PCB改善案例丨PCB 沉铜流程深度剖析及孔无铜问题改善策略
一、沉铜工序流程与作用
1.沉铜在PCB中作用介绍

化学镀铜:通常叫沉铜或孔化(英文:Eletcroless Plating Copper ,PTH )是实现印制板的层间电气互连,对绝缘基材表面进行金属化处理的制程。
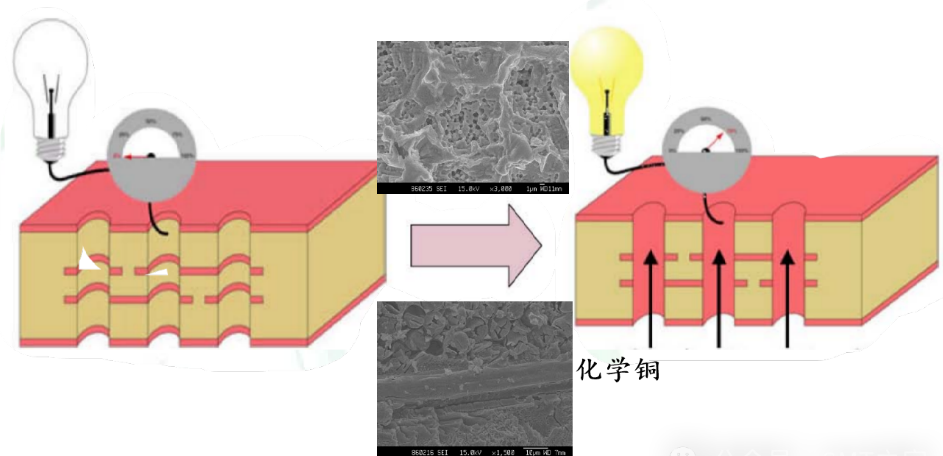
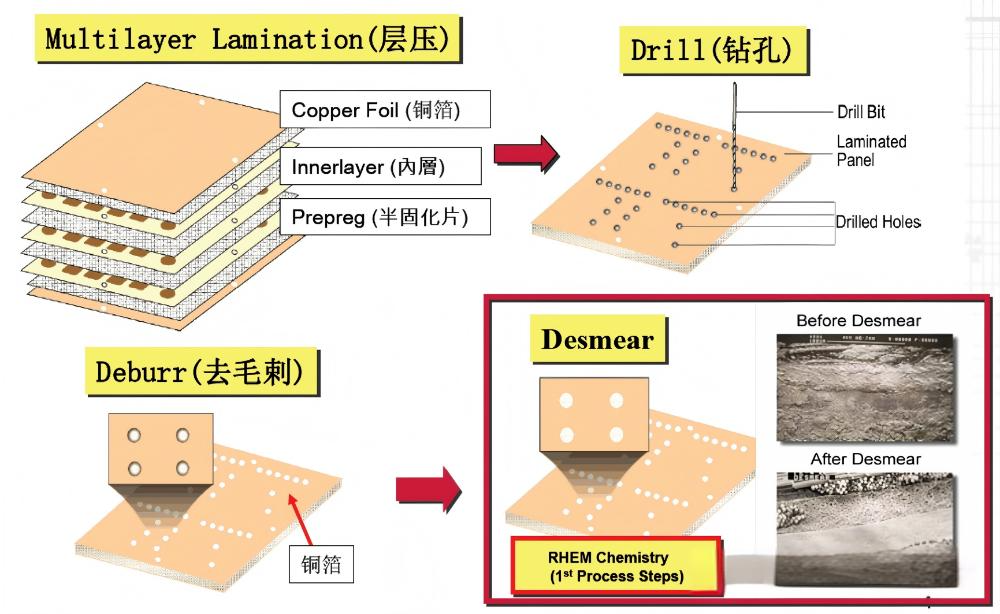
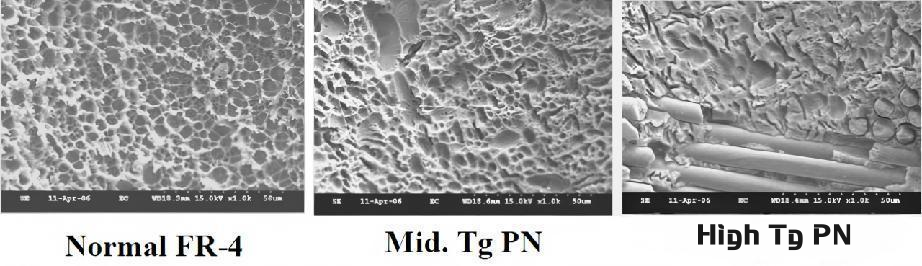


2.沉铜流程介绍
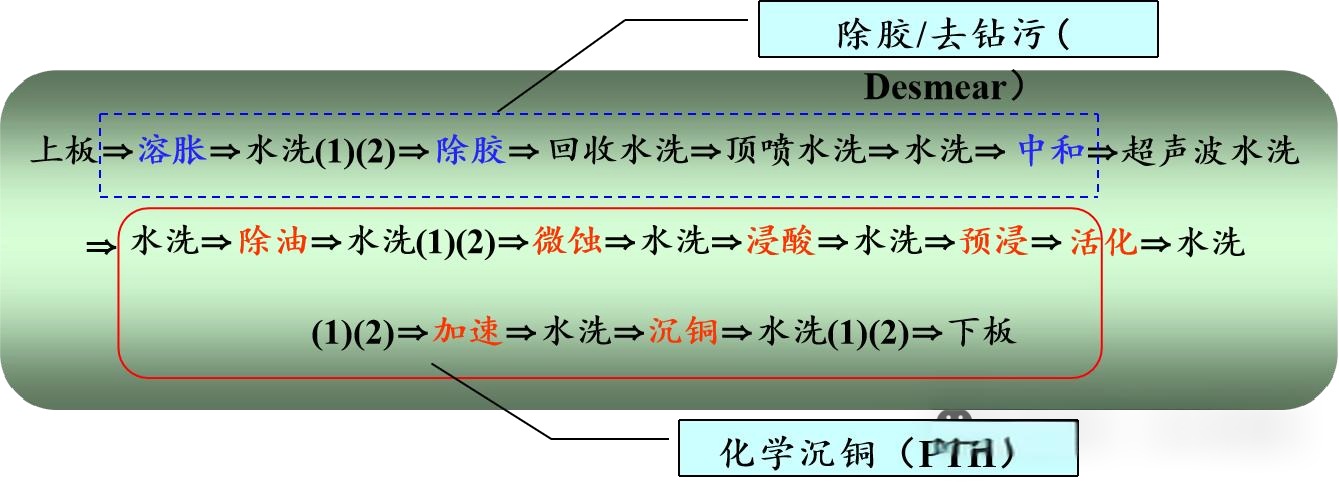
二、沉铜工序作用机制
各流程作用机制
各流程控制要点
1.各流程作用机制
膨胀
原 理: 环氧树脂是高聚形化合物,具有优良的耐蚀性,其腐蚀形式主要有溶解、溶胀和化学裂解(如浓硫酸对环氧树脂主要是溶解作用,其凹蚀作用是十分明显的)根据“相似相溶”的经验规律,醚类有机物一般极性较弱,且有与环氧树脂有相似的分子结构(R-O-R')所以对环氧树脂有一定的溶解性。因为醚能与水发生氢键缔合,所以在水中有一定的溶解性。因此,常用水溶性的醚类有机物作为去钻污的溶胀剂。


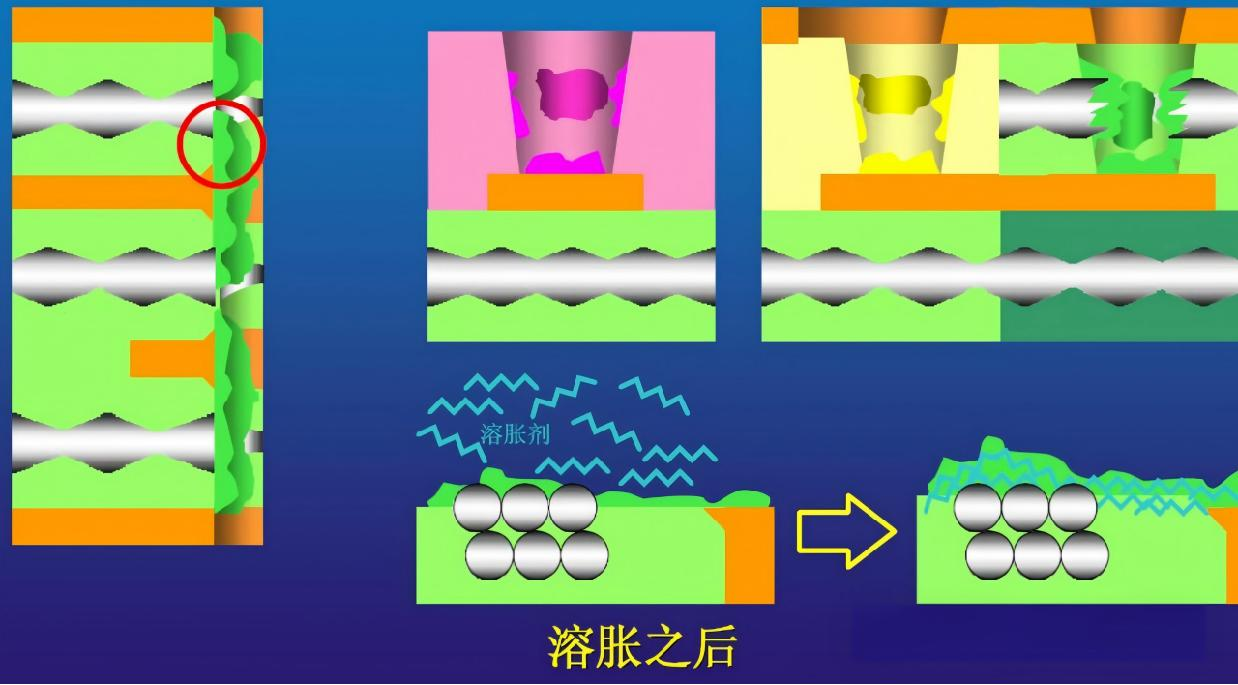
除胶
原理:在高温碱性条件下,高锰酸钾使环氧树脂碳链氧化裂解:

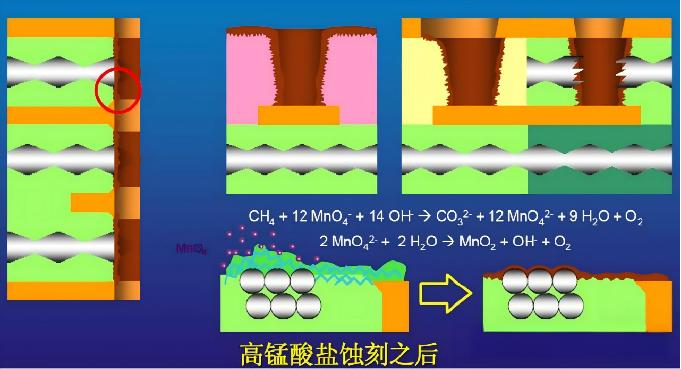
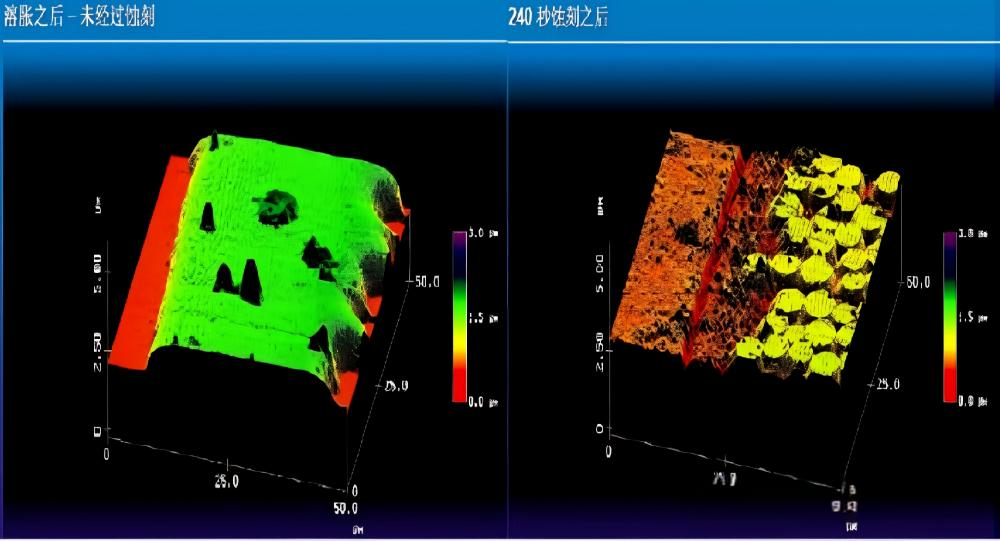
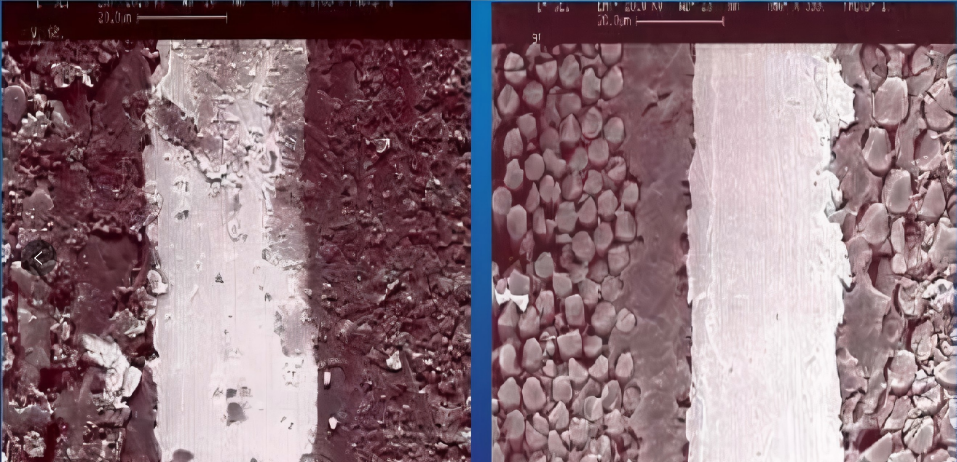
中和
原理:锰离子是重金属离子,它的存在会引起“钯中毒”,使钯离子或原子失去活化活性,从而导致孔金属化的失败。因此,化学沉铜前必须去除锰的存在。
在酸性介质中:

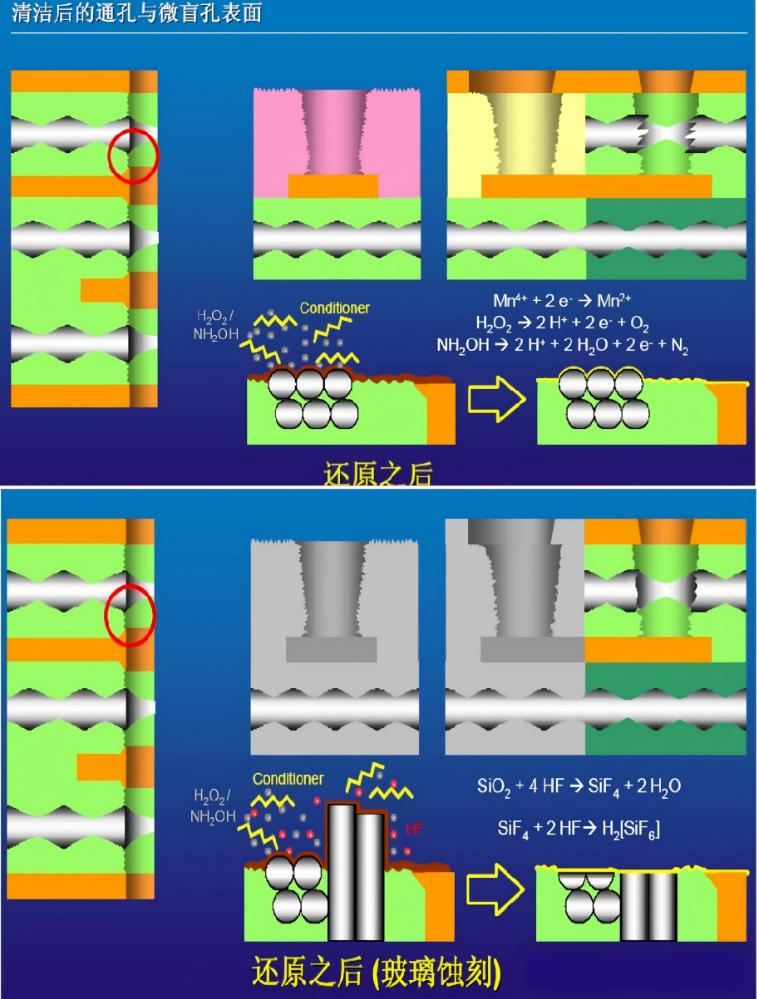

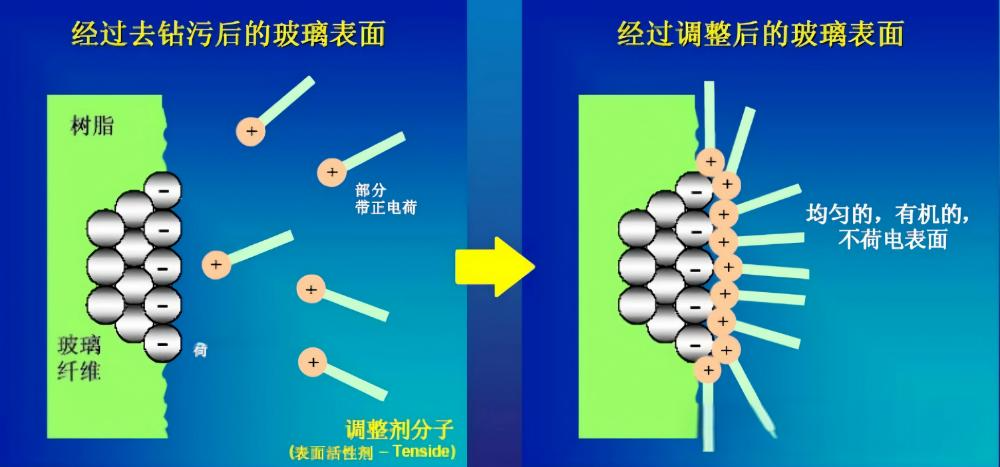
微蚀

功能:
a.除去铜表面的有机薄膜;
b.微观粗化铜表面
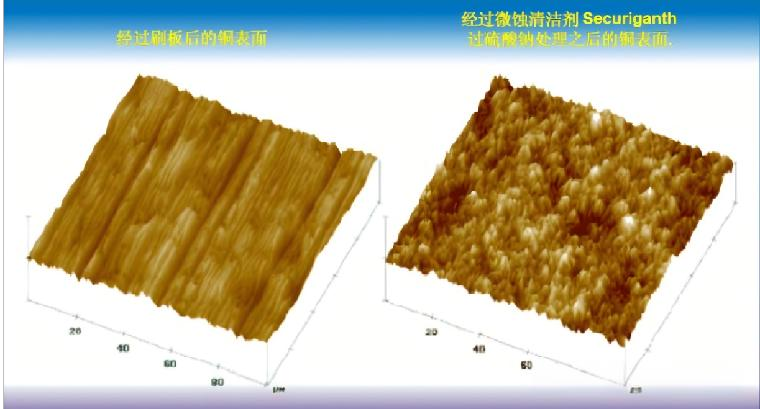


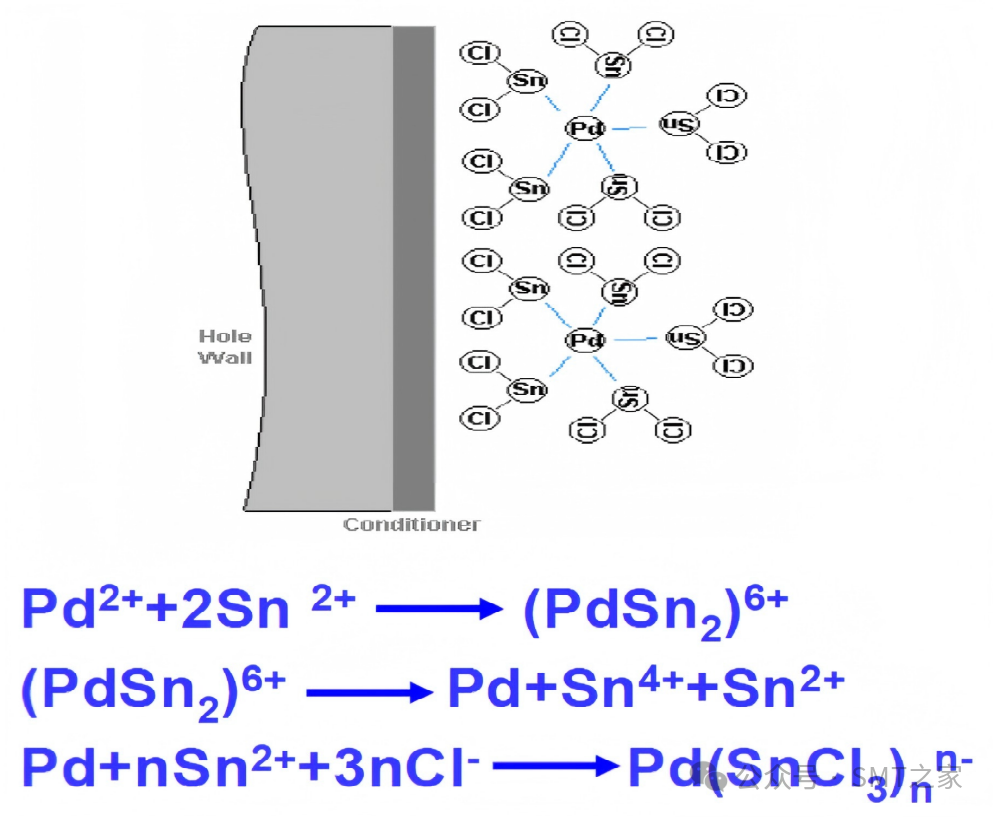

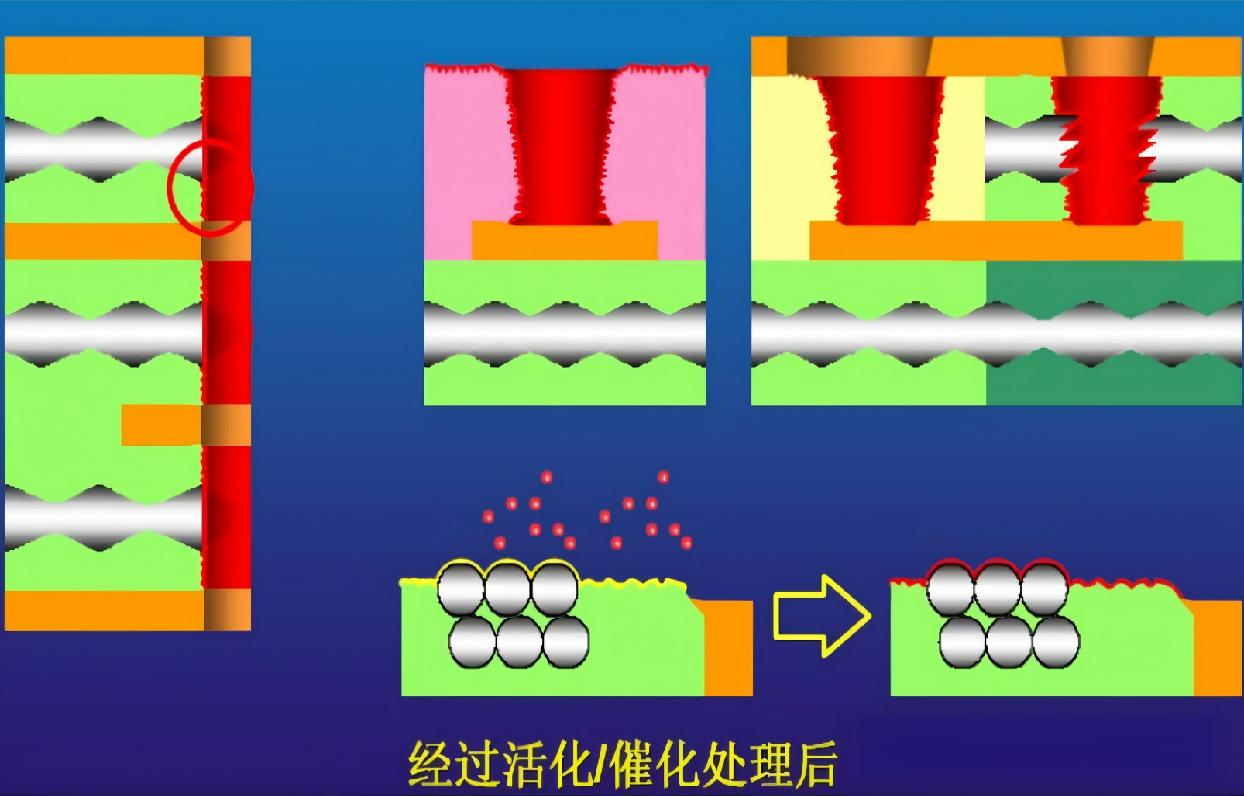
加速

功能:剥去Pd外层的Sn4+外壳,露出Pd金属,清除松散不实的钯团或钯离子、原子等。
原理:钯胶团粘附的板子,在经水洗,在鼓气的作用下,Pd粒外会形成Sn(OH)4外壳.通过HBF4型加速剂使等除去。
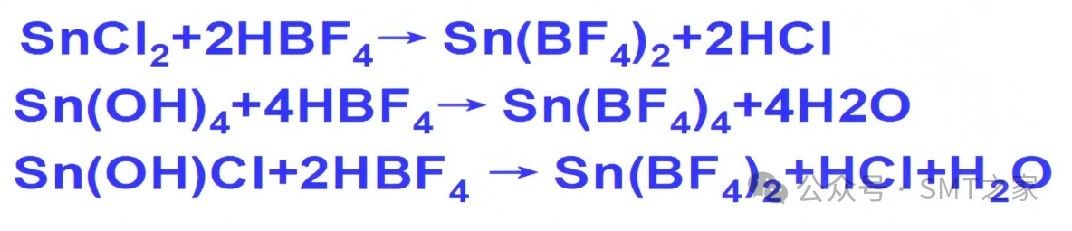
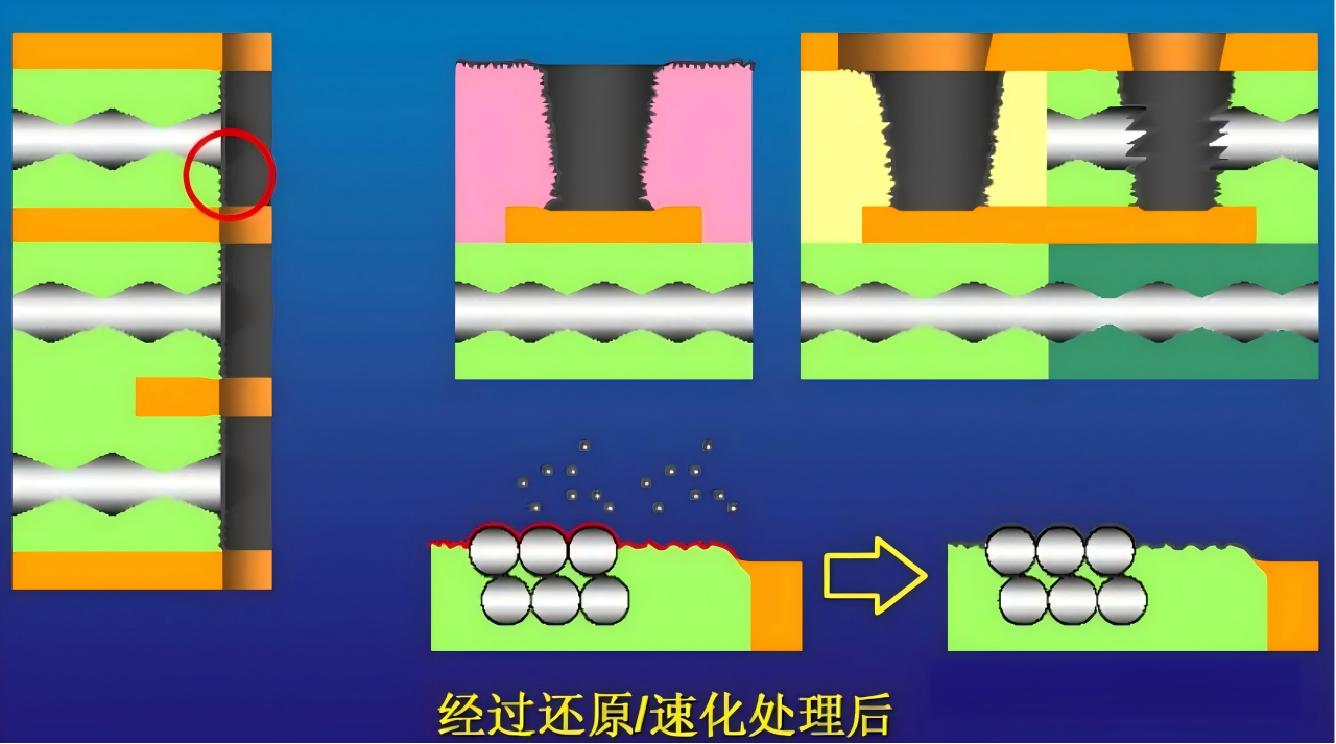
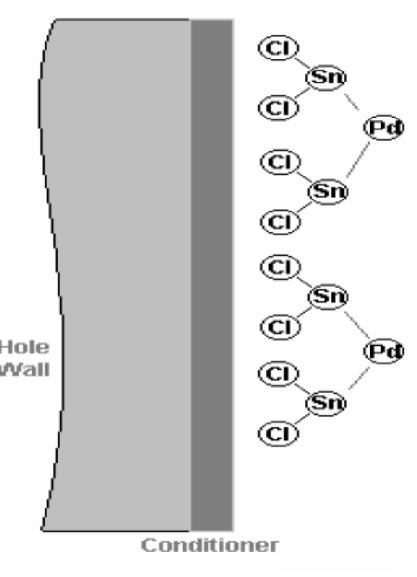

化学沉铜的类型可分为薄铜(0.25-0.5μm)、中铜(1-1.5μm)及厚铜(2-2.5μm)
功能:在钯的催化作用下被甲醛还原而沉于钯上,
原理:


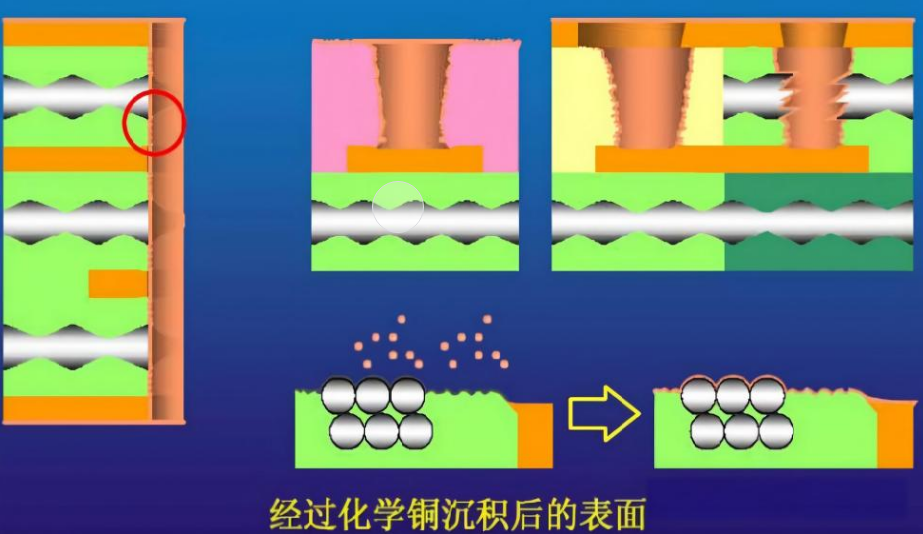

沉铜设备类型

2.沉铜生产管理
药品名称 | 备注 | 药品名称 | 备注 |
NaOH | AR 级别 | MLB211 | 溶胀 |
KMnO4 | AR 级别 | MLB233 | 除油 |
HCHO | AR 级别 | C/P 404 | 活化盐 |
NaPS | AR 级别 | CAT44 | 钯液 |
H2SO4 | AR 级别 | ACC19 | 加速剂 |
MLB 213 B-1 | 除胶 | 253A | 沉铜 |
MLB 216 | 中和 | 253E | 沉铜 |