PCB过孔堵塞原因及作用解析
2025-06-25 10:19:50
890
为满足客户对导通孔的质量要求,PCB线路板需进行导通孔塞孔处理。经大量生产实践验证,采用白网印刷工艺替代传统铝片塞孔,可同步实现板面阻焊与塞孔工序。该工艺显著提升生产稳定性,确保塞孔质量可靠可控。
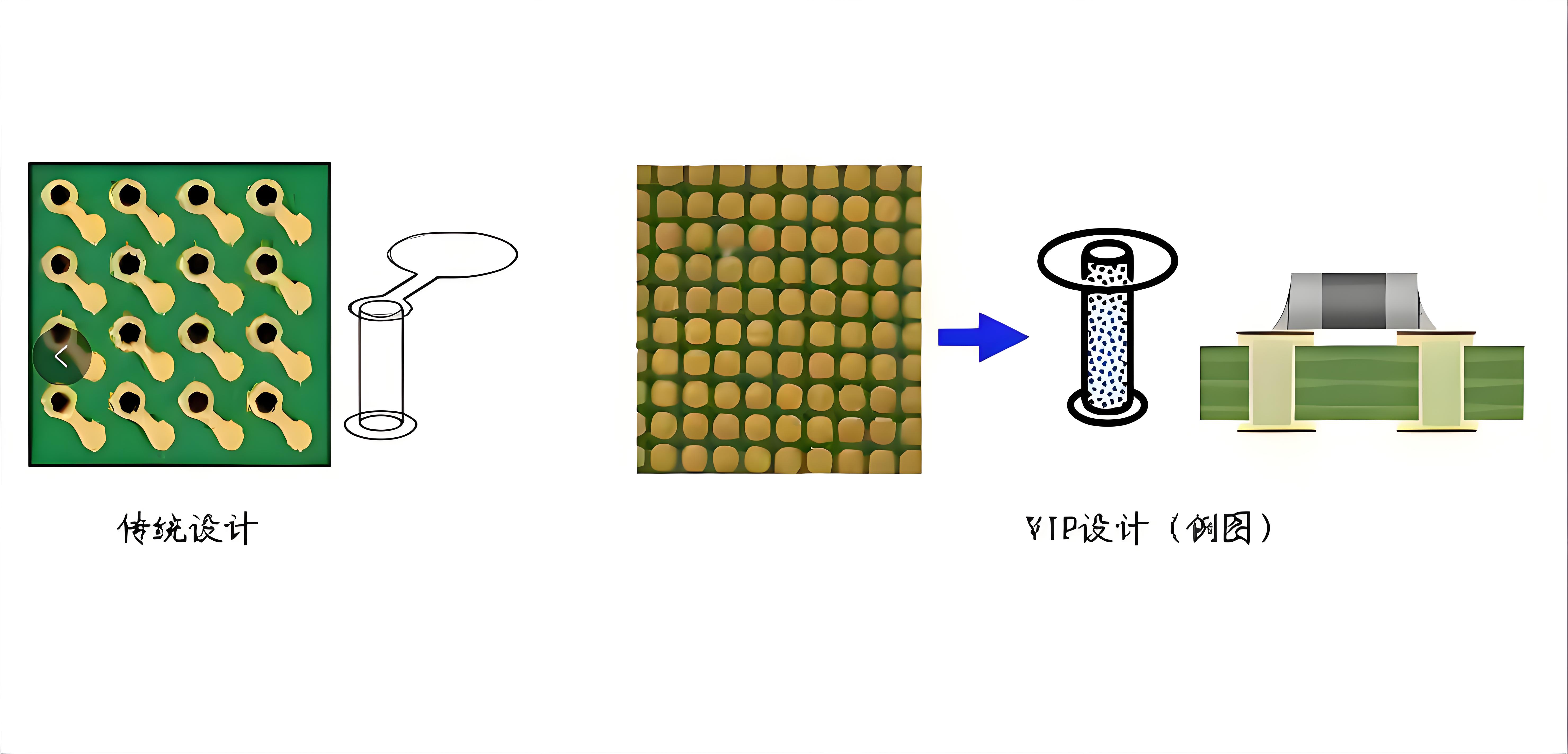
导通孔作为PCB电气互联的关键通道,其塞孔工艺随电子设备"轻、薄、短、小"化及高密度互连(HDI)需求而发展。为满足SMT/BGA封装等精密贴装要求,塞孔工艺需符合以下三类标准:
| 要求等级 | 技术指标 |
|---|---|
| 基础级 | 孔内铜层完整,阻焊塞孔非强制(可选择性填充) |
| 波峰焊防护级 | 孔内镀锡铅层≥4μm,严禁阻焊油墨入孔(避免藏锡珠) |
| 高可靠性级 | 阻焊油墨完全填孔,孔口平整(凹凸公差±1mil)、不透光、无锡圈/锡珠 |
塞孔工艺的五大核心作用
防波峰焊透锡短路:阻断熔锡经导通孔贯穿至元件面,BGA焊盘下方过孔必须预塞孔并镀金;
阻隔助焊剂残留:避免化学物质滞留孔内导致腐蚀;
保障真空测试密封性:满足SMT后测试机负压吸附的物理密封需求;
预防锡膏流失虚焊:阻止表面贴装时锡膏渗入孔内;
抑制锡珠飞溅短路:消除波峰焊过程中锡珠弹射风险。
工艺难点与解决方案
当前塞孔工艺存在三大挑战:
流程复杂:工序链条长,过程控制点繁多;
质量风险:热风整平(HASL)时易掉油、固化后爆油;
精度要求:BGA/IC区域孔口平整度需控制在±1mil内,杜绝边缘发红上锡。
热风整平(HASL)原理:通过高温热风刮除板面及孔内多余焊料,使锡层均匀覆盖焊盘/线路,属PCB表面处理工艺。
工艺优化方向:基于量产实践,现对主流塞孔工艺(树脂塞孔、电镀填孔、铝片塞孔等)进行系统性对比,从流程效率、缺陷率、成本三维度解析优劣,为工艺选型提供依据。
热风整平后塞孔工艺
流程:板面阻焊 → HAL(热风整平) → 塞孔 → 固化
核心方法
采用铝片网版/挡墨网进行后处理塞孔
油墨选择:感光油墨或热固性油墨(须与板面色泽一致)
优势:杜绝热风整平后孔内掉油
缺陷
油墨污染:塞孔操作易污染板面
平整度不足:孔口凹凸导致BGA区域虚焊风险
客户接受度低:多数高密度贴装客户禁用此工艺
热风整平前塞孔工艺(铝片塞孔方案)
流程:前处理 → 铝片塞孔 → 固化 → 磨板 → 图形转移 → 蚀刻 → 板面阻焊
技术关键
精密治具:数控钻床定制铝片网版,确保孔内填充饱满
油墨特性:高硬度热固性油墨(低收缩率+强孔壁附着力)
镀铜要求:孔壁铜厚需选择性加厚至客户标准
优势
孔口平整无凹陷
通过热风整平考验(无爆油/孔边掉油)
实施瓶颈
工艺门槛:
需整板镀铜能力(精准控制孔壁铜厚)
高性能磨板设备(彻底清除铜面树脂残留)
普及局限:因设备/技术限制,仅少数PCB厂采用
工艺对比决策指南
| 评估维度 | 热风整平后塞孔 | 热风整平前铝片塞孔 |
|---|---|---|
| 平整度 | ≤0.05mm波动(虚焊高风险) | ≤0.025mm(满足BGA贴装) |
| 可靠性 | 板面污染风险高 | 通过HAL爆油测试 |
| 设备依赖 | 常规设备 | 需精密磨板+选择镀铜 |
| 客户认可度 | 消费类电子 | 高可靠BGA/IC封装 |
2.2 铝片塞孔后直接丝印阻焊工艺
流程:前处理 → 铝片塞孔(数控网版) → 30分钟内丝印阻焊(36T网) → 预烘 → 曝光显影 → 固化
优势
孔口平整无凹陷
阻焊颜色一致性高
有效阻隔热风整平上锡(孔内无锡珠)
致命缺陷
油墨溢染焊盘:固化后孔周油墨爬升导致可焊性劣化
孔边起泡掉油:热风整平后孔缘附着力失效(需特殊工艺参数调控)
关键控制点:塞孔后须30分钟内完成丝印,防止油墨流变
2.3 铝片塞孔+预固化后阻焊工艺
流程:前处理 → 铝片塞孔(饱满凸出) → 预烘 → 显影 → 预固化 → 磨板 → 板面阻焊
优势:彻底杜绝热风整平掉油/爆油
未解难题
孔内锡珠残留:热风整平后导通孔藏锡率>15%
孔壁上锡:阻焊覆盖不全导致锡层攀附(客户验收不合格主因)
2.4 板面阻焊与塞孔同步工艺(量产优选)
流程:前处理 → 同步丝印(36T/43T网+钉床垫板) → 预烘 → 曝光显影 → 固化
突破性改良
工艺创新:
油墨选型:高触变型树脂(粘度>120 Pa·s)
设备参数:丝印压力0.4±0.1MPa + 二次抽真空除气
量产表现
| 指标 | 改良前 | 改良后 |
|---|---|---|
| 孔内空洞率 | 22% | ≤3% |
| 热风整平藏锡率 | 15% | ≤1% |
| 平整度 | ±2.5mil | ±0.8mil |
现存挑战
深径比>8:1的微孔需定制化开发油墨配方
四大工艺决策矩阵
| 评估项 | 2.2直接丝印法 | 2.3预固化法 | 2.4同步法 |
|---|---|---|---|
| 热风整平合格率 | 65% | 82% | 96% |
| BGA区域风险 | 虚焊高风险 | 藏锡珠拒收 | 零上锡 |
| 量产稳定性 | 依赖人工调参 | 设备制约 | 全自动化 |
| 客户认可度 | 消费电子 | 工业控制 | 通信/医疗 |
