PCB板常见的表面工艺介绍
由于铜长期与空气接触会使得铜氧化,所有我们在PCB表面需要做一些处理,这样才可以保证PCB板的可焊性和电性能。
目前常见的处理工艺有:喷锡(Hot Air Solder Leveling,HASL热风整平)、OSP(防氧化)、全板镀镍金、沉金、沉锡、沉银、化学镍钯金、电镀硬金等,下面我们就对这些处理工艺做一个详细的介绍。
① HASL工艺的优点是:价格较低,焊接性能佳。
② HASL工艺的缺点是:不适合用来焊接细间隙的引脚及过小的元器件,因为喷锡板的表面平整度较差,且在后续组装过程中容易产生锡珠(Solder bead),对细间隙引脚(Fine pitch)元器件较易造成短路。

(有铅喷锡)

OSP不同于其它表面处理工艺之处为:它的作用是在铜和空气间充当阻隔层;简单地说,OSP就是在洁净的裸铜表面上,以化学的方法长出一层有机皮膜。这层膜具有防氧化,耐热冲击,耐湿性,用以保护铜表面于常态环境中不再继续生锈(氧化或硫化等);同时又必须在后续的焊接高温中,能很容易被助焊剂所迅速清除,以便焊接。
有机涂覆工艺简单,成本低廉,使得其在业界被广泛使用。早期的有机涂覆分子是起防锈作用的咪唑和苯并三唑,最新的分子主要是苯并咪唑。为了保证可以进行多次回流焊,铜面上只有一层的有机涂覆层是不行的,必须有很多层,这就是为什么化学槽中通常需要添加铜液。在涂覆第一层之后,涂覆层吸附铜;接着第二层的有机涂覆分子与铜结合,直至二十甚至上百次的有机涂覆分子集结在铜面。
其一般流程为:脱脂-->微蚀-->酸洗-->纯水清洗-->有机涂覆-->清洗,过程控制相对其他表明处理工艺较为容易。
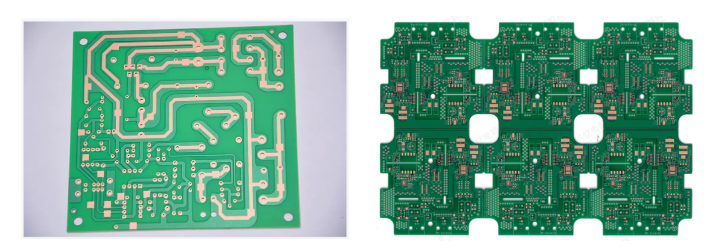
(OSP工艺)
镀镍的原因是由于金和铜之间会相互扩散,而镍层可以阻止其之间的扩散,如果没有镍层的阻隔,金将会在数小时内扩散到铜中去。化学镀镍/沉金的另一个好处是镍的强度,仅仅5um厚度的镍就可以控制高温下Z方向的膨胀。此外化学镀镍/浸金也可以阻止铜的溶解,这将有益于无铅焊接。
其一般流程为:脱酸洗清洁-->微蚀-->预浸-->活化-->化学镀镍-->化学沉金;其过程中有6个化学槽,涉及到近百种化学品,过程比较复杂。

(高TG沉金PCB电路板)

(镀镍工艺PCB)
沉银是置换反应,它几乎是亚微米级的纯银涂覆。有时沉银过程中还包含一些有机物,主要是防止银腐蚀和消除银迁移问题,一般很难量测出来这一薄层的有机物,分析表明有机体的重量少于1%。

(沉银工艺PCB)
沉锡工艺可以形成平坦的铜锡金属间化合物,这个特性使得沉锡具有和热风整平一样的好的可焊性而没有热风整平令人头疼的平坦性问题;也没有化学镀镍/沉金金属间的扩散问题;只是沉锡板不可以存储太久。

(沉锡工艺PCB)


现在在表面处理工艺中热风整平用的会比较多,热风整平工艺对于尺寸较大的元件和间距较大的导线而言,是非常好的,但是对于密度比较高的PCB不太实用,热风整平的平坦性会影响后续的组装,所以一般HDI板不采用此工艺。
有机涂覆使用的范围就比较广了,由于价格比较便宜,在低密度和高密度的PCB当中都有较广泛的应用,所以在表面连接功能性要求时有机涂覆时最理想的表面处理工艺。
化学镀镍通常应用在连接功能性要求比较长的存储板上面和我们的有机涂覆相反,一般在手机和路由器中都有应用
最后沉银通常时介于有机涂覆和化学镀镍之中的一种工艺,如果PCB对连接性功能有一定的要求,有需要降低成本那么侵银通常时最优的选择。
再价格方面也是有显著区别的,拿沉金和有机喷锡还有无铅喷锡以及OSP工艺举例,在其他条件相同的情况下沉金工艺一般比较贵的,依次是OSP,无铅喷锡,有铅喷锡价格最便宜
