
为何陶瓷基板成为高性能电子封装的首选
电子封装基板主要有塑料、金属和陶瓷三大类型。其中,塑料基板导热性较差,长期可靠性不足;金属基板虽导热性好,但热膨胀系数常与芯片不匹配,且成本偏高。因此,在高性能要求的场合,陶瓷基板成为更理想的选择。
与塑料和金属基板相比,陶瓷基板具有以下综合优势:
绝缘性能优良,可靠性高;
介电常数低,高频特性好;
热膨胀系数低,热导率高;
气密性佳,化学性质稳定,能够为电子系统提供有效保护。
因此,陶瓷基板尤其适用于航空、航天、军事等对可靠性、高频性能、耐高温及气密性要求较高的产品封装。同时,在移动通信、计算机、家用电器和汽车电子等领域,超小型片式电子元器件也普遍采用陶瓷基板作为载体材料。
目前常用的陶瓷基板材料包括氧化铝(Al₂O₃)、氮化铝(AlN)、氮化硅(Si₃N₄)、碳化硅(SiC)、氮化硼(BN)和氧化铍(BeO)等。

电子封装陶瓷
各类型陶瓷基板的应用领域:
1. 氧化铝陶瓷基板
Al₂O₃陶瓷基板应用广泛,产量大,但其热导率相对较低,限制了其在高频、大功率及超大规模集成电路中的应用。
2. 氮化铝陶瓷基板
AlN陶瓷具有优良的热导率,但其粉末制备工艺复杂、能耗高、成本昂贵,因此主要用于高端行业。
3. 氮化硅陶瓷基板
Si₃N₄陶瓷介电性能一般(介电常数约8.3,介电损耗0.001–0.1),且生产成本较高,限制了其在电子封装中的广泛应用。
4. 碳化硅陶瓷基板
SiC介电常数较高,约为AlN的4倍,抗压强度较低,适用于低密度封装,主要用于集成电路元件、阵列元件、激光二极管及导电结构元件。
5. 氧化铍陶瓷基板
BeO陶瓷热导率高、高频特性优异,但因其毒性限制了应用范围。目前主要用于大功率晶体管的散热片、高频大功率半导体器件、发射管、行波管、激光管、速调管等,以及航空电子和卫星通信领域。
6. 氮化硼陶瓷基板
BN陶瓷热导率高且稳定,介电常数小,绝缘性能好,广泛应用于雷达窗口、大功率晶体管基座、管壳、散热片及微波输出窗口等场合。
各类陶瓷基板性能对比:
| 性能指标 | 单位 | AlN | Al₂O₃ | BeO | SiC | BN | Si₃N₄ |
|---|---|---|---|---|---|---|---|
| 含量 | % | 95 | 96.0 | 99.5 | 99.0 | – | 99–99.7 |
| 密度 | g/cm³ | ≥3.32 | 3.72 | 3.90 | 2.52 | 1.6–2.0 | 3.26±0.05 |
| 最高使用温度 | ℃ | 800 | 1700 | 1750 | – | 1300 | 900–2100 |
| 导热系数(20℃) | W/(m·K) | – | 24.70 | 30.00 | 230 | 90–110 | 35–85 |
| 导热系数(100℃) | W/(m·K) | 170 | – | – | – | – | – |
| 热膨胀系数 | ×10⁻⁶/℃ | ||||||
| (25–400℃) | 4.4 | – | – | – | 4.0 | 0.7–7.5 | |
| (25–800℃) | – | 8.2 | 8.2 | 7.0–8.5 | – | – | |
| (20–100℃) | – | – | – | – | 1.5–2.8 | – | |
| 电阻率(25℃) | Ω·cm | >10¹⁴ | >10¹⁵ | >10¹⁵ | ≥10¹⁴ | – | >10¹⁸ |
| 电阻率(300℃) | Ω·cm | – | – | – | ≥10¹¹ | – | – |
| 介电常数(1MHz) | – | 8.9 | 8.3 | 8.7 | 6.9±0.4 | 40 | 9.4 |
| 介电损耗(1MHz) | ×10⁻⁴ | 3–10 | 0.0002 | 0.0001 | – | – | – |
| 耐电压 | kV/mm | 15 | 10 | 10 | 10 | 0.07 | 300–400 |
| 硬度(HV) | MPa | 1000 | 25 | 12 | 91–93 | – | 160–1800 |
| 弯曲强度 | MPa | ≥410 | 300–350 | 200 | ≥350 | 40–80 | 700–800 |
| 弹性模量 | GPa | 320 | 370 | 350 | 350 | – | 320 |
| 毒性 | – | 无 | 无 | 有 | 无 | 无 | 无 |
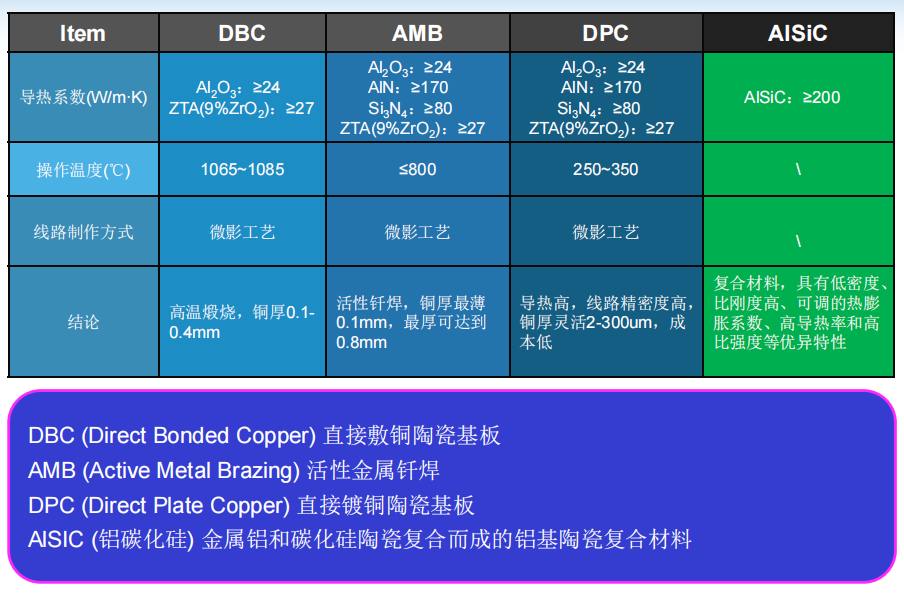
百能云板陶瓷基板部分产品展示
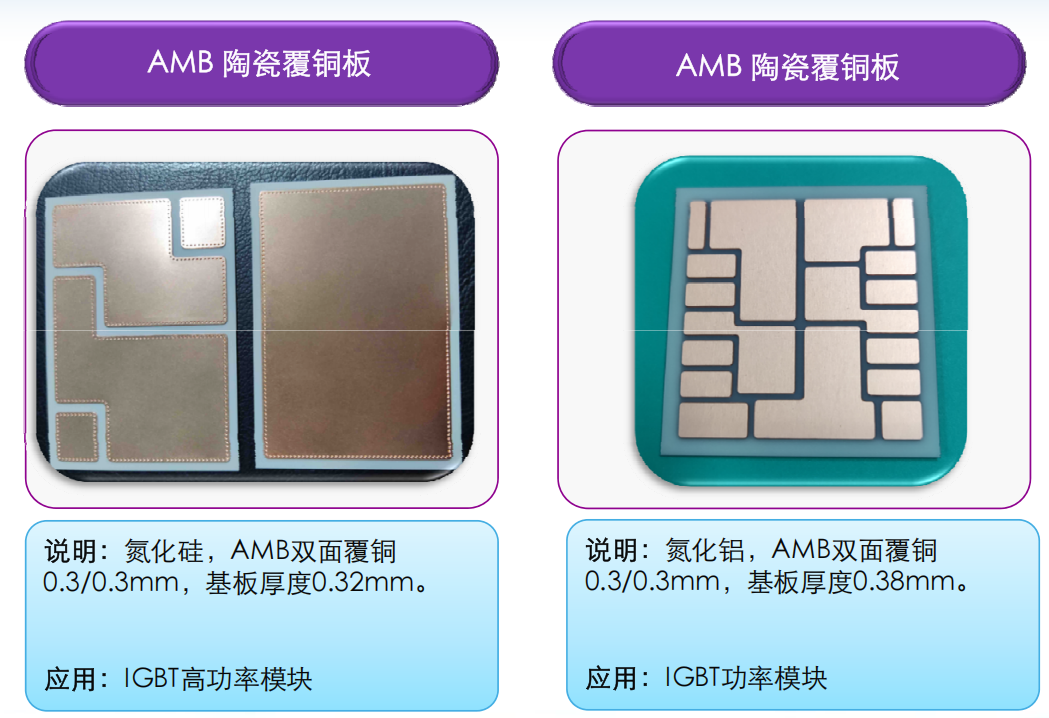
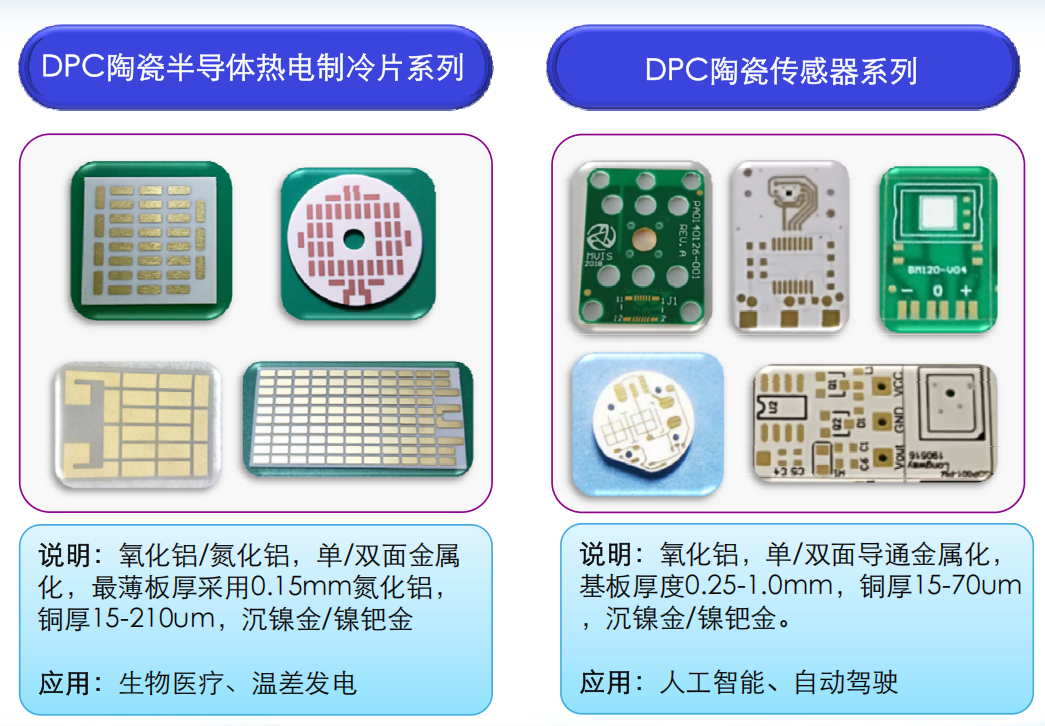
热门新闻

方寸铸硬核,精工造非凡|百能云板12层3阶HDI板,助力工业智能进阶

AI高功耗倒逼材料迭代:陶瓷基板开启PCB替代与国产替代新周期




