
玻璃基板在半导体中的应用
随着半导体进入先进封装时代,玻璃基板凭借其独特的材料属性,成为解决性能与成本挑战的关键答案。
核心价值:从“稳定基底”到“性能引擎”
特性: 超高平坦度、与硅匹配的低CTE、优异绝缘性。
优势: 实现更精细的电路布线,保障高频信号传输质量,从根本上缓解热应力导致的面板翘曲。
收益: 直接助力芯片实现更高集成度、更快传输速度与更高良率。
应用场景:攻克高密度与高频技术壁垒
玻璃基板是HBM实现更高堆叠与带宽、硅光子实现低损耗光互联的理想选择,为AI/数据中心等前沿领域提供底层支持。
成本革命:面板级工艺开启规模效应
从圆形“晶圆”到方形“面板”的制造范式变革,大幅提升单次生产的芯片数量,是驱动单位成本下降30-40%的根本原因。
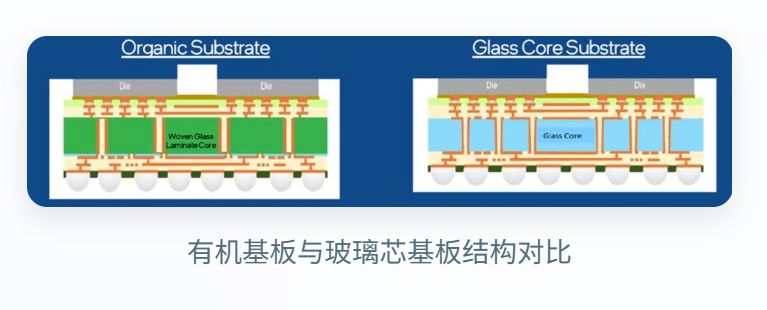
玻璃基板性能优势


玻璃基板的关键应用场景

Chiplet/SiP & AI/HPC
玻璃基板价值: 极高的平坦度和稳定性支持更细的布线,实现高密度互连;优良的介电特性保障了高速信号的完整性,是HBM和计算芯粒的理想互联载体。
需求: 高I/O密度、超短互联链路、低信号损耗、高带宽、低串扰。
硅光子/CPO
需求: 光学透明度、低损耗光波导、光电集成。
玻璃基板价值: 不仅可作为透明衬底直接集成光路,其低损耗特性更是高效光子传输的关键,有力支撑了共封装光学等前沿技术。
通信/射频
需求: 控制高频信号损耗、精确的阻抗匹配。
玻璃基板价值: 稳定的介电常数和低损耗因子使其在GHz乃至THz频率下仍能保持优异的信号质量,非常适合高性能射频模块与天线封装。
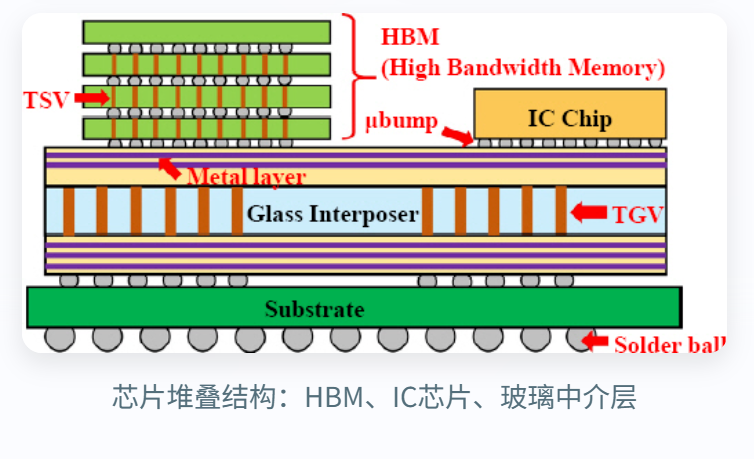
玻璃基板技术发展路线图
近期 (1-3年):技术攻坚与工艺验证
核心技术指标:
实现TGV(玻璃通孔)孔径 < 5 μm,深宽比 (AR) > 10:1。
实现RDL(重布线层)线宽/线距 < 2 μm。
阶段目标: 完成核心工艺能力的建立与原型验证,为规模化量产奠定基础。
中期 (3-5年):规模量产与成本优化
产业重点:
攻克大尺寸面板级工艺的良率瓶颈,实现良率稳步提升。
推动产业链成熟,达到成本下降的“拐点”。
推动接口、材料与工艺的标准化进程。
阶段目标: 实现从实验室到工厂的跨越,使玻璃基板在经济性上具备市场竞争力。
长期 (5年以上):生态成熟与主流应用
应用驱动:
推动CPO(共封装光学)与SiPh(硅光子)技术的大规模商业化应用。
愿景目标: 玻璃基板成为高端先进封装领域的主流方案之一,尤其在2.5D/3D封装和光电子集成领域占据主导地位。
百能云板玻璃基板产品







