

陶瓷基板:Al₂O₃、AlN、Si₃N₄该如何选择?
在陶瓷基板领域,氧化铝、氮化铝与氮化硅并非简单的替代关系,而是在性能、成本与场景的博弈中,逐步形成“三分天下”的稳定结构。
2025-10-09 10:09
772

光模块需求因 AI 大涨:氮化铝多层厚薄膜技术深度解析
氮化铝多层薄厚膜是一种以高热导率氮化铝陶瓷为基材,通过 “内层厚膜(HTCC)构建三维互联骨架 + 表层薄膜实现精密信号布线” 的复合工艺基板技术。它并非简单的工艺叠加,而是针对高端电子器件 “高功率散热难、高频信号损耗大、高密度集成受限” 的核心痛点
2025-09-26 11:07
1297
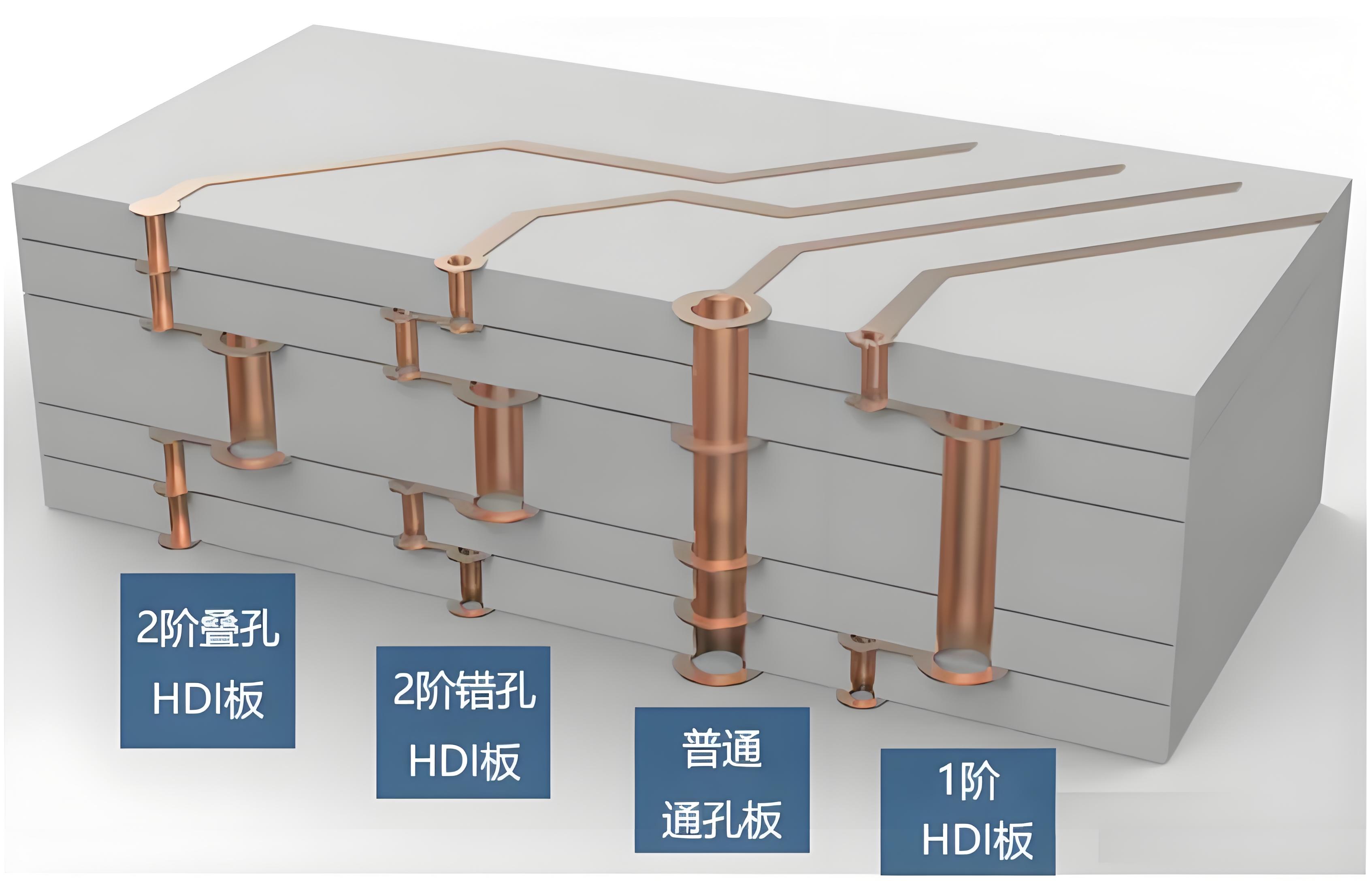
HDI板应用场景与传统PCB设计差异探讨
HDI板已成为高端电子产品的标配。其应用场景从消费电子到尖端科技无处不在,核心价值在于它突破了传统PCB的物理限制。在选择设计方案时,当产品面临空间受限、功能高度集成、信号速度极高的挑战时,采用HDI技术就不再是“选项”,而是“必然”。
2025-09-23 14:26
983

SiC芯片与陶瓷基板连接:钎焊还是烧结?终极选择取决于应用场景
行业普遍采用的两种连接工艺——钎焊与烧结,虽然目标都是实现芯片与基板的牢固结合,但其内在原理和最终性能表现却存在天壤之别,直接决定了功率模块的可靠性、寿命乃至整体性能。要洞察二者的优劣,必须从最根本的“连接机理”入手。
2025-09-19 11:44
1092

PCB嵌埋式封装之S-Cell
嵌埋式封装技术应运而生,S-Cell 作为其代表,通过芯片埋入PCB的革新设计,彻底颠覆传统封装局限,成为追求极高功率密度、超高效能应用的终极解决方案。
2025-09-16 11:45
1846

