SiC功率器件核心材料——AMB陶瓷基板及钎焊工艺
在电动汽车市场,消费者的核心关切聚焦于续航里程与充电焦虑两大痛点,这一趋势正深刻引领着行业发展方向。为积极响应市场需求,国内顶尖车企已抢先布局,纷纷推出搭载800V高压快充技术的车型,旨在从根本上缓解消费者的续航焦虑,加速充电过程。随着政府政策的鼎力支持及行业技术标准的日益完善,高压快充技术的应用边界正迅速拓展,预示着电动汽车充电体验的全面升级。
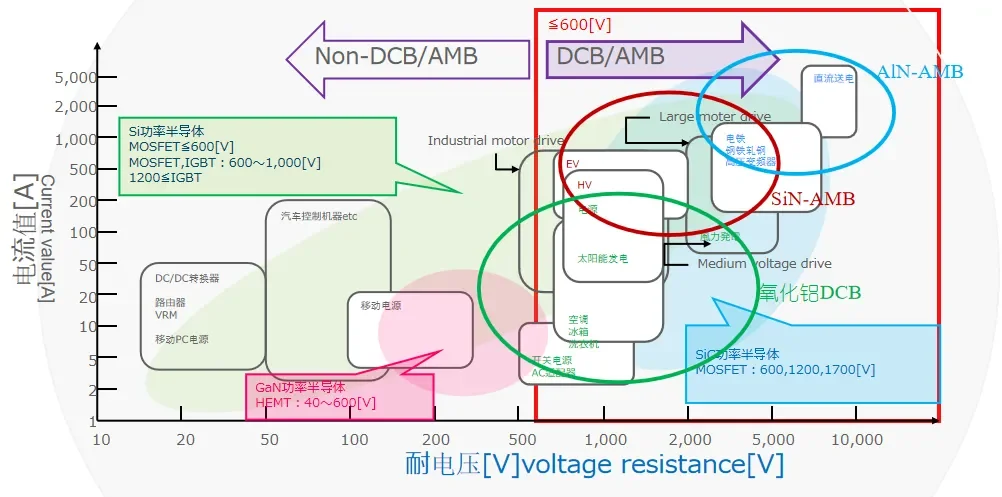
在此背景下,SiC(碳化硅)材料以其卓越的高频、高压、高温耐受性,以及出色的散热性能、紧凑体积、低能耗特性和高功率输出能力,成为了新能源汽车领域内的明星材料。SiC的应用不仅为新能源汽车赋予了“高压+长续航”的双重优势,更被视为解决当前行业瓶颈、推动新能源汽车产业迈向新高度的关键钥匙。因此,“SiC上车”已成为新能源汽车产业热议的焦点话题,预示着一场由材料创新引领的技术革命正在加速到来。
AMB陶瓷基板成SiC功率器件首选
陶瓷基板按照工艺主要分为DBC、AMB、DPC、HTCC、LTCC等基板,按照基板材料划分主要为氧化铝(Al2O3)、氮化铝(AlN)和氮化硅(Si3N4),其中氧化铝陶瓷基板最常用,主要采用DBC工艺;氮化铝陶瓷基板导热率较高,主要采用DBC和AMB工艺;氮化硅可靠性优秀,主要采用AMB工艺。
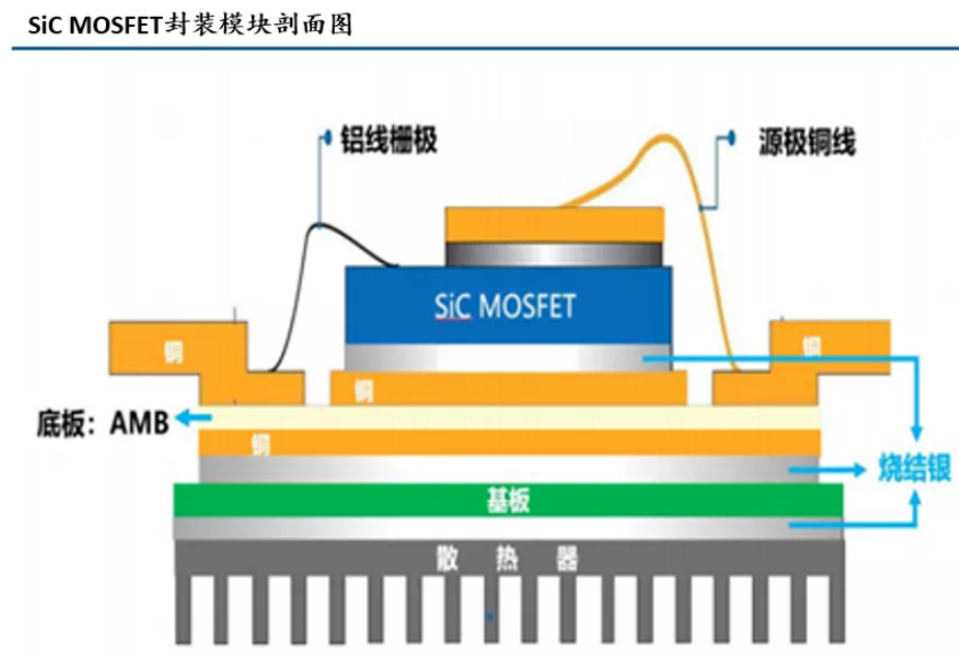
直接覆铜(DBC)陶瓷基板是通过共晶键合法制备而成,铜和陶瓷之间没有粘结材料,在高温服役过程中,往往会因为铜和陶瓷(Al2O3或AlN)之间的热膨胀系数不同而产生较大的热应力,从而导致铜层从陶瓷表面剥离,因此传统的DBC陶瓷基板已经难以满足高温、大功率、高散热、高可靠性的封装要求。活性金属钎焊(AMB)基板主要是将活性钎料通过厚膜印刷或以焊片形式置于陶瓷载板表面层,再将铜箔层放置在覆有金属焊料的陶瓷载板两侧,形成铜-钎料-陶瓷-钎料-铜的结构,并依次层叠组装、真空烧结,使陶瓷、钎料和铜箔三者成紧密焊接,而后经曝光、显影、蚀刻和表面处理等工艺制成的产品。通过AMB工艺形成的铜/陶瓷界面粘结强度更高,且相比Al2O3和AlN,Si3N4陶瓷同时兼顾了优异的机械性能和良好的导热性,因此Si3N4-AMB覆铜基板在高温下的服役可靠性更强,是SiC器件封装基板的首选。AMB基板作为SiC功率模块的核心配套材料,将伴随SiC功率模块上车在新能源汽车领域取得突破,除此之外高性能AMB基板还能应用在光伏新能源、轨道交通等终端行业中的IGBT模块、SiC功率器件、碳化硅超高压电控及电驱平台等。钎焊是AMB陶瓷基板制程中最重要的工序,活性钎料的制备和活性金属钎焊是目前的重点和难点。Ti、Zr、Hf、V、Nb等是常见的几种活性金属元素,可以浸润陶瓷表面,被广泛用于陶瓷与金属的活性封接。其中以Ti为活性元素的Ag-Cu-Ti系合金是研究最多、实际应用最为广泛的一种活性钎料,其在800~950 ℃的温度下可以润湿大多数陶瓷表面,钎焊接头强度高、性能稳定,从而可以较好地实现陶瓷和金属、陶瓷和陶瓷的封接。
Ag-Cu-Ti系活性钎料的使用形式包括以下四种,随Ti元素的形态、钎料的组合方式不同而有所不同:①预涂Ti粉(或TiH,粉)膏剂,然后加预成形焊片(通常为Ag72Cu28合金焊片);②预先在陶瓷表面以PVD(物理气相沉积)或CVD(化学气相沉积)镀一层Ti薄膜,然后再加Ag-Cu钎料。AMB覆铜陶瓷基板一般采用银铜钛焊片或印刷焊膏,但这两种方法都存在一定局限:①焊片工艺所用的银铜钛焊片在制备过程中容易出现活性元素Ti的氧化、偏析问题,导致成材率极低,焊接接头性能较差。②对于焊膏工艺,在高真空中加热时有大量有机物挥发,导致钎焊界面不致密,出现较多空洞,使得基板在服役过程中易出现高压击穿、诱发裂纹的问题。使用银铜钛活性钎料制备AMB陶瓷覆铜基板时,导致界面空洞的原因主要有几点:①原料表面质量:焊接前陶瓷和无氧铜表面的划痕、凹坑、氧化、有机污染的问题都会对焊料的润湿铺展造成负面影响,为钎焊界面带来了潜在的空洞风险。②焊料印刷质量:大面积焊膏印刷过程中,较易出现焊膏漏印、印刷不均匀的问题,焊料熔化后一旦没有铺展覆盖这些漏印区域,就会直接导致空洞的形成。③活性元素失活:AgCuTi焊膏中的活性元素Ti对氧十分敏感,高温钎焊过程中,往往要求真空度优于10-3Pa,若真空度无法满足焊接要求导致Ti氧化失活,焊料无法润湿陶瓷表面,会造成大面积虚焊、漏焊等现象。④焊膏挥发气体:钎焊过程中,焊膏中挥发出的气体会被助焊剂包裹形成气泡,此外助焊剂中的有机酸和金属氧化物反应也会产生气泡,随着反应的进行气泡逐渐变大,排出的气泡会在焊膏表面留下密密麻麻的气孔,而未排出的气泡同样会随着焊料熔化凝固的过程滞留在钎焊界面处,形成空洞。⑤钎焊工艺参数:Ag-Cu-Ti活性钎料往往在800 ℃以上才能润湿Si3N4表面,若钎焊温度过低或保温时间过短,将会使得Ti与陶瓷表面的反应不够充分,导致钎料无法完全润湿陶瓷表面。AMB氮化硅覆铜基板的制备过程中,在空洞率控制方面,高真空或高真空+惰性气体的钎焊环境、预脱脂的钎焊工艺、适当的钎焊压力、原材料的清洗(对陶瓷和铜片进行除油和除氧化处理)都可以降低钎焊界面空洞率。