
首页/新闻动态/什么是LTCC封装技术,一文全面了解LTCC封装技术
什么是LTCC封装技术,一文全面了解LTCC封装技术
LTCC(Low Temperature Co-fired Ceramic,低温共烧陶瓷)封装技术是一种先进的电子封装技术,它将低温烧结的陶瓷粉体与金属导体浆料混合后,在多层陶瓷基板上进行布图设计,并经过叠层、切割、排胶、烧结等工艺步骤,最终形成一个三维结构的多层陶瓷封装体。
LTCC基板进行陶瓷封装可以提高组件(模块)对于高频、低损耗、高速传输、小型化等的封装要求。LTCC封装产品在航天、航空、通信、雷达等领域已得到重要应用,在要求更高数据传输速率和带宽以及更低延迟的5G领域也已大量使用LTCC产品,LTCC封装产品使用频率已超过 100 GHz,具有广阔的发展前景和应用市场。
一、LTCC封装的类型
LTCC基板可进行不同形式的封装。选择热膨胀系数与 LTCC基板相近和密度适当的金属外壳与 LTCC基板焊接可实现 LTCC金属外壳封装,LTCC金属外壳封装气密性好、通用性强。LTCC基板与金属围框结合可实现具有不同引脚形式的针栅阵列(Pin Grid Array, PGA)封装、焊球阵列(Ball Grid Array, BGA)封装、穿墙无引脚封装、四面引脚扁平(Quad Flat Package, QFP)封装、无引脚片式载体(Leadless Chip Carrier, LCC)封装和三维多芯片模块(Three-Dimensional Multichip Module, 3D-MCM)封装等气密性 LTCC一体化封装。
(1)LTCC金属外壳封装
LTCC金属外壳封装与传统厚膜多层氧化铝基板金属外壳封装相似,是将 LTCC 基板焊接或粘接在金属外壳内部底面上,通过金属外壳上镶嵌的绝缘子或连接器实现外壳内外电连接的一种封装,通常用于高可靠性的电子产品或定制的有特殊性能要求的军事或航空航天产品中。
(2)LTCC针栅阵列封装
LTCC针栅阵列封装是在LTCC基板表面焊接金属围框作为封装框体、底面焊接金属 PGA 作为 I/O 端的一种封装。将 LTCC电路基板作为封装载体在基板上直接引出封装的 I/O 端子,使基板与围框和盖板成为一个整体的封装也称为 LTCC(/金属)一体化封装。在 LTCC基板上焊接围框后再组装元器件,即可通过平行缝焊等封上盖板实现气密性封装。
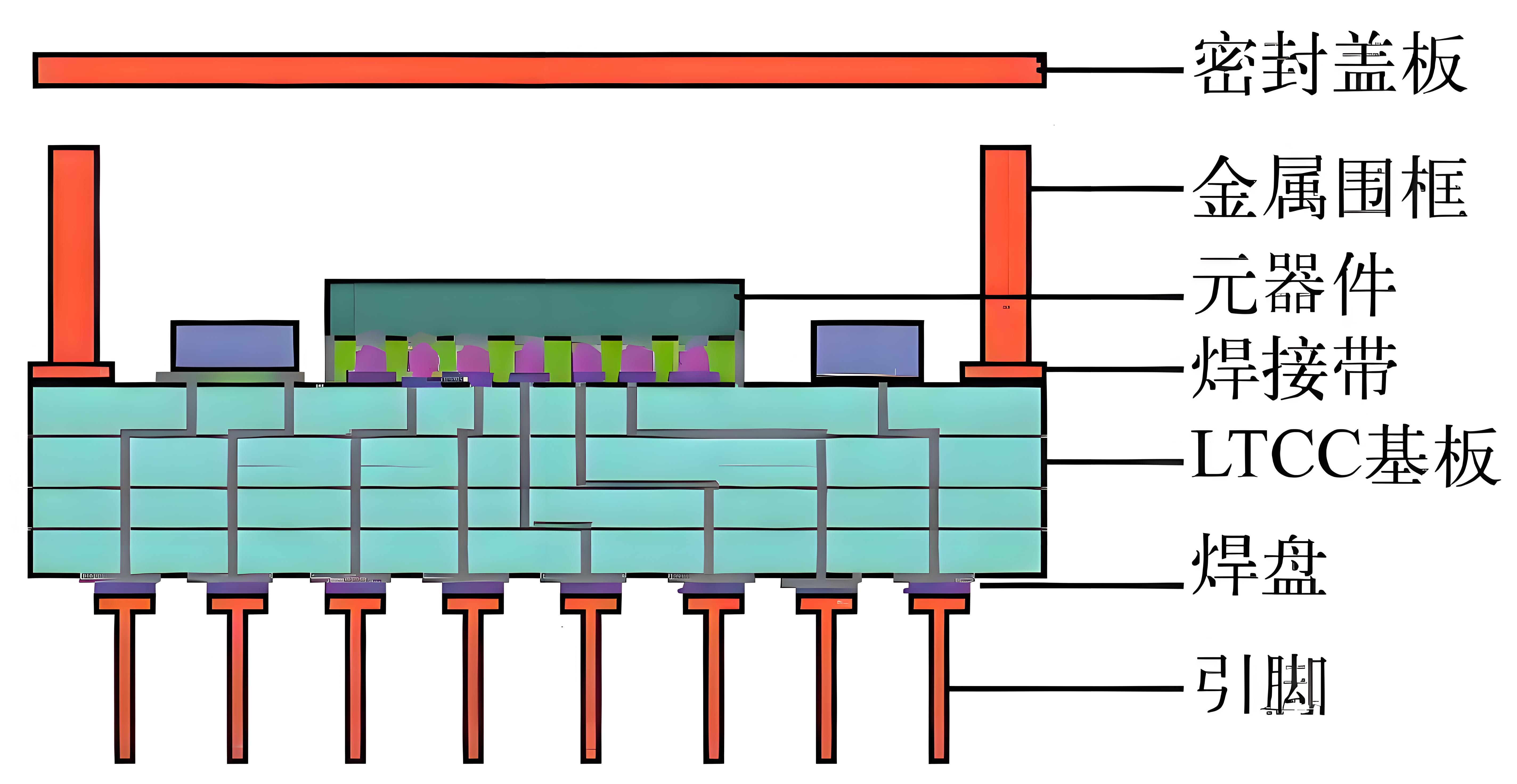
(3)LTCC 焊球阵列封装
LTCC焊球阵列封装是 LTCC基板表面焊接金属围框作为封装框体、底面焊接焊球作为 I/O 端的一种封装。LTCC BGA气密性封装也属于 LTCC一体化封装。
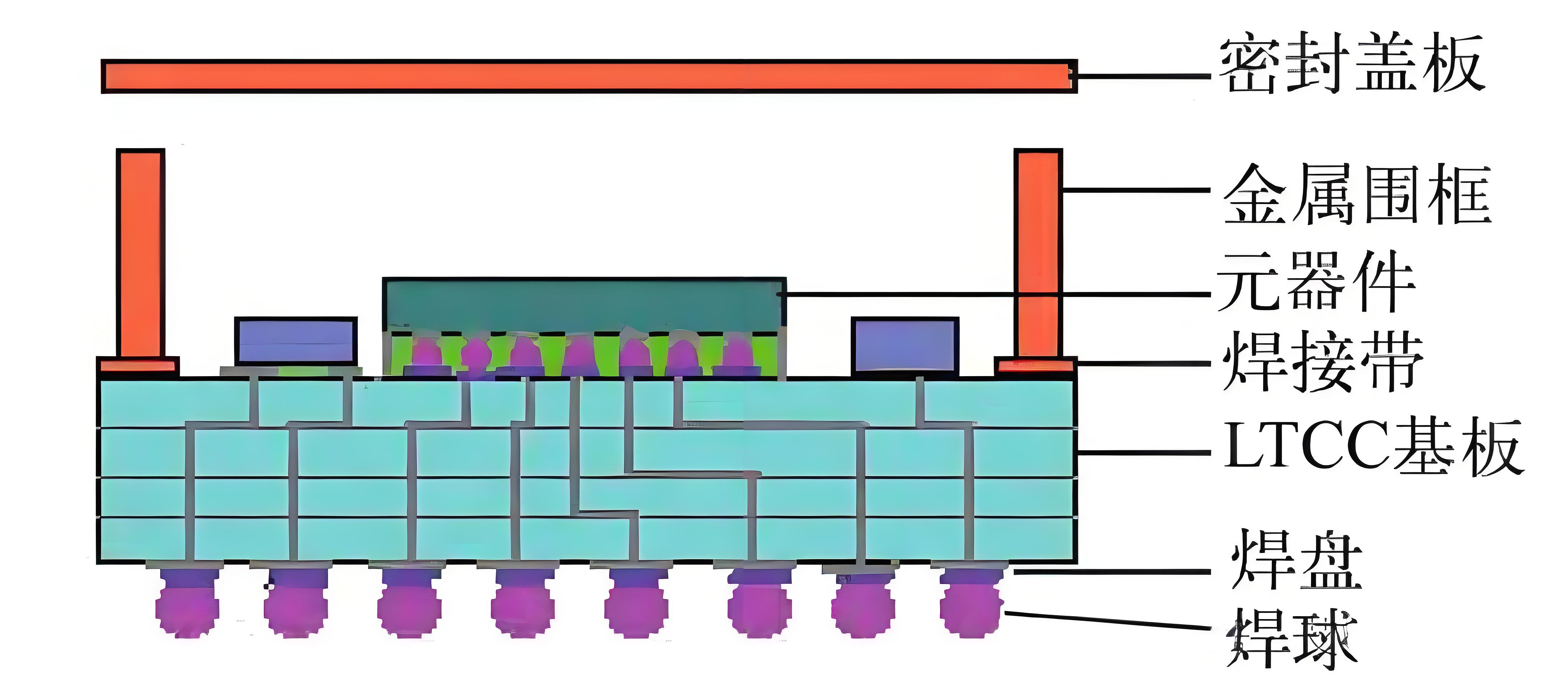
(4)LTCC 穿墙无引脚封装
LTCC 穿墙无引脚封装是 LTCC 基板表面焊接金属围框作为封装框体、I/O 端头为从 LTCC 基板内部引出到围框外侧的金属化导带的一种封装形式。穿墙是金属化导带从框内穿过金属围框下部的瓷体而出现在围框外部,该导带与 LTLTCC基板共烧而成。通过穿墙导带可以将组件的引出线从密封的腔体内部引出来。LTCC 穿墙无引脚封装也是一种 LTCC 一体化封装。

5)LTCC 四面引脚扁平封装
LTCC 四面引脚扁平封装是 LTCC 基板表面焊接金属围框作为封装框体、基板底面边缘焊接引线作为 I/O 端的一种封装,LTCC QFP 封装也属于 LTCC 一体化封装。
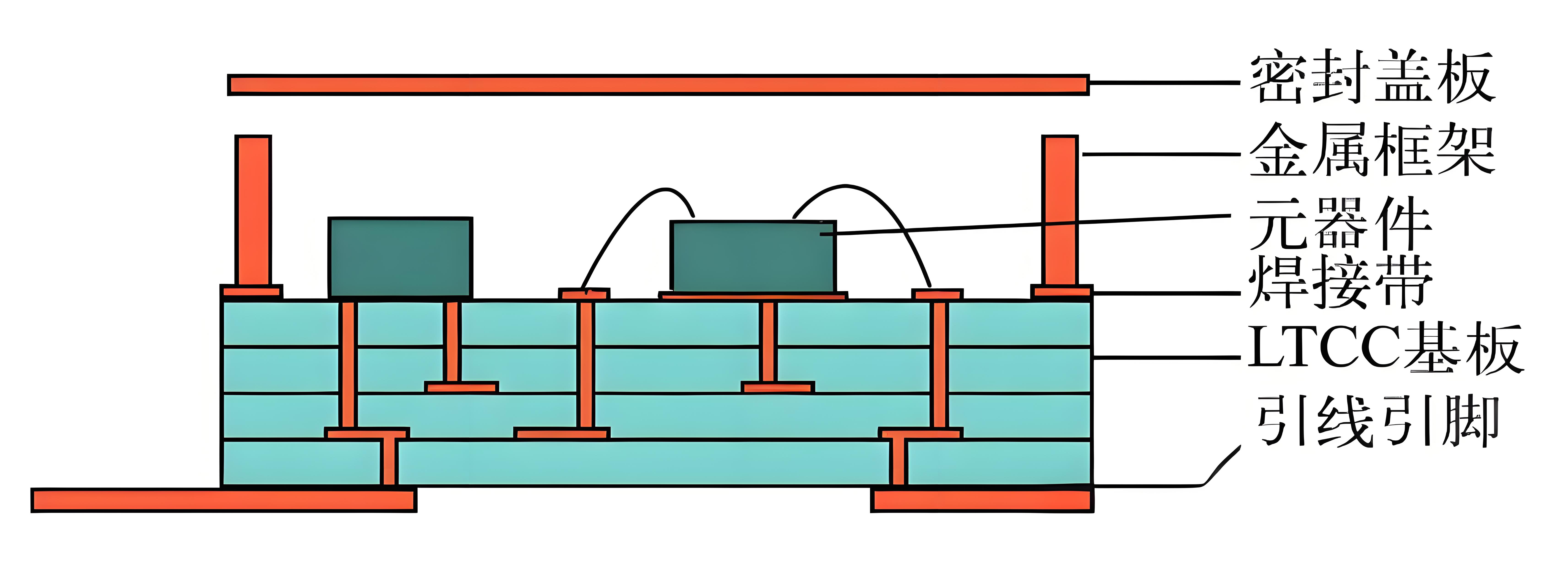
(6)LTCC无引脚片式载体封装
LTCC无引脚片式载体封装是 LTCC基板表面焊接金属围框作为封装框体、 I/O 端头为从 LTCC基板内部引出到基板底部的导体膜层的一种封装形式,属于LTCC一体化封装。
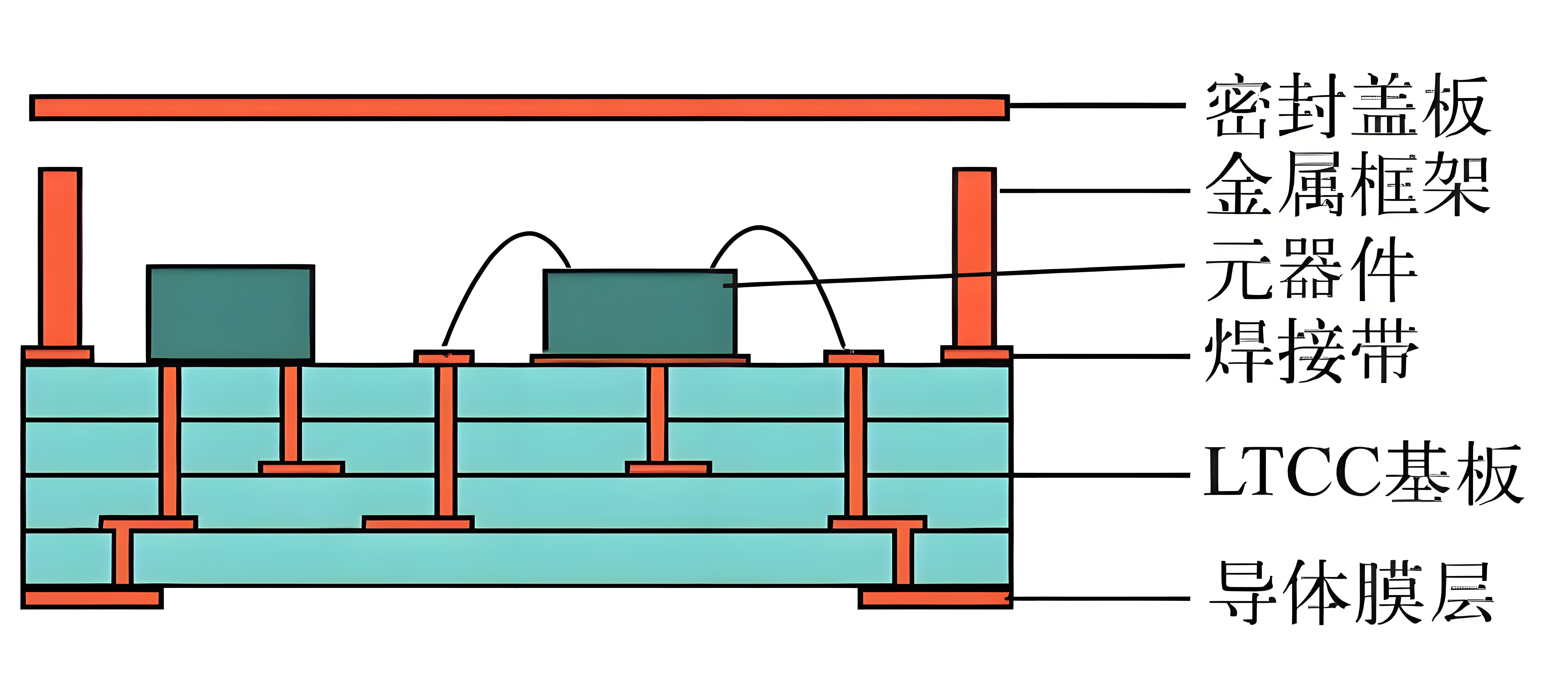
(7)LTCC 3D-MCM 封装
LTCC三维多芯片模块封装是将多块(不少于2块)二维板级 LTCC模块(2D-MCMD垂直叠装并实现电连接和机械连接所形成组件的封装。采用垂直互连制作的 LTCC 3D-MCM不仅模块所占投影表面积和体积缩小,重量减轻,而且由于垂直互连线缩短,互连线阻值、寄生电容和电感减小,信号延迟缩短,噪声和损耗将下降,可以进一步提高信号传输速度。LTCC 3D-MCM封装可以是气密性封装,独立形成多功能模块或子系统;也可以是非气密性封装,构成 3D-MCM后再组装到系统(或子系统)载板上,成为载板上的一部分。

二、LTCC 封装用材料
完整的LTCC封装应是所有有源器件和无源元件均组装到基板以后,再焊接上盖板成为一个密封整体。LTCC封装材料是指用于承载电子元器件及其相互连线,起到机械支撑、密封环境保护、信号传递、散热和屏蔽等作用的基体材料,包括 LTCC基板、布线、壳体、框架、热沉、盖板、焊料等材料,总体上分为LTCC基板材料、封装金属材料和焊接材料三大类。
(1)LTCC 基板材料
LTCC是以玻璃/陶瓷材料作为电路的介电层,运用 Au、Ag、Pd/Ag 等高电导率金属做内外层电极和布线,以平行印刷方式印制多层电路,叠压后在低于950℃的烧结炉中共同烧结而成的一种陶瓷,LTCC基板具有布线导体方阻小、可布线层数多、布线密度高、烧结温度低、介质损耗小、高频性能优异、热膨胀系数与多种芯片匹配等优点,因而成为一种理想的高密度集成用主导基板。LTCC基板材料包括 LTCC生瓷带和与生瓷带配套的导体和电阻等材料。生瓷带主要有玻璃陶瓷系(微晶玻璃)和玻璃+陶瓷系两类,导体材料主要为 Au、Ag、Pd、Pt 等贵金属及其合金。

(2)LTCC 封装金属材料
LTCC封装金属材料主要根据金属封装材料特性进行选择,需要综合考虑金属材料的热导率、热膨胀系数、密度、可焊性、工艺成熟性等。
①可伐合金(Fe-Ni-Co)热膨胀系数较小,与常用 LTCC基片热膨胀系数相匹配,具有较好的加工性,成本较低,是一种较常用的金属管壳材料。
②CuW和CuMo合金则结合了 W、Mo 和 Cu 的许多优异特性,从而具有良好的导热导电性、耐电弧侵蚀性、抗熔焊性和耐高温、抗氧化性等特点,并且热膨胀系数可在一定范围内选择,主要应用于大规模集成电路和大功率微波器件中,作为热控板、散热元件(热沉材料)和引线框架使用。
③AlSiC具有高热导率、低膨胀系数、高强度、低密度、良好的导电性等特点,作为基板或热沉材料在国内封装领域已得到批量应用。
(3)LTCC 封装焊接材料
LTCC封装焊接材料主要作为连接材料,用于 LTCC基板与金属底板、金属围框、引脚的焊接,基板上元器件组装、焊球连接及基板垂直互连等。LTCC封装用焊接材料熔点一般低于 450℃,属于软钎料。
LTCC封装焊接材料有焊膏和焊片,焊膏更适合微小元器件和焊球等多点位置的焊接,焊片常用于围框、基板等面积相对较大的焊件和精确尺寸(焊料逸出少)焊件的焊接。






