
首页/新闻动态/一文看懂 DBC 直接覆铜陶瓷基板:结构、工艺与应用全解析
一文看懂 DBC 直接覆铜陶瓷基板:结构、工艺与应用全解析
直接覆铜陶瓷基板(DBC)是一种将高绝缘性的氧化铝(AI2O3)或氮化铝(AIN)陶瓷基板覆上铜金属的新型复合材料。它是通过在高温下将铜与陶瓷表面直接结合而成的,无需中间层或粘合剂。根据陶瓷材料的不同,DBC基板可以分为氧化铝直接覆铜基板(AI2O3-DBC)和氮化铝直接覆铜基板(AIN-DBC)。如今被广泛应用于大功率电力电子模块中,如汽车电子、IGBT、激光器(LD)和聚焦光伏(CPV)等。
直接覆铜陶瓷基板(DBC):高功率电子的核心散热解决方案
1. 技术原理与材料革新
DBC(Direct Bonded Copper)是一种通过高温共晶技术将铜箔直接键合到氧化铝(Al₂O₃)或氮化铝(AlN)陶瓷基板表面的复合材料。其核心工艺突破在于:
零中间层键合:无需粘合剂,通过铜与陶瓷的原子扩散形成冶金结合,确保界面热阻 < 1.0 K・cm²/W;
双材料协同优势:陶瓷提供高绝缘性(>10 kV/mm)与化学稳定性,铜层实现优异导电性(IACS≥98%)与导热性(Al₂O₃-DBC 导热率≈24 W/(m・K),AlN-DBC≈170 W/(m・K))。
2. 分类与性能对比
| 类型 | 导热率 | 热膨胀系数 | 绝缘强度 | 典型应用 |
|---|---|---|---|---|
| Al₂O₃-DBC | 24 W/(m·K) | 7.2×10⁻⁶/K | 15 kV/mm | IGBT 模块、LED 散热基板 |
| AlN-DBC | 170 W/(m·K) | 4.3×10⁻⁶/K | 12 kV/mm | 激光二极管、新能源汽车电机控制器 |
3. 核心优势解析
散热性能突破:铜层厚度可定制(0.1-3 mm),满足 100-1000 W/cm² 功率密度器件需求;
可靠性提升:耐高温冲击(-55℃~+250℃)、抗热疲劳(循环寿命 > 10⁶次),适用于严苛环境;
集成化设计:可实现精密线路图形(线宽 / 线距≤50 μm),支持多芯片封装。
一、DBC工艺流程、材料及原理
1、工艺流程
陶瓷基片和铜箔的清洗烘干→铜箔预处理→铜箔与陶瓷基片的高温共晶键合→冷热阶梯循环冷却→质检→按要求刻蚀图形→化学镀镍(或镀金)→质检→激光划片、切割→成品质检→真空或充氮气包装→入成品库。
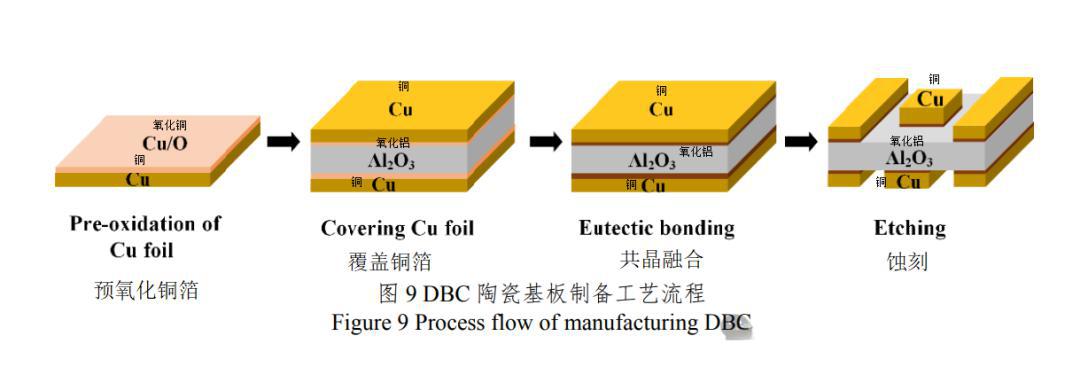
虽然 DBC 基板在实际应用中有诸多优势,但在制备过程中要严格控制共品温度及氧含量,对设备和工艺控制要求较高,生产成本也较高。此外,由于厚铜刻蚀限制,无法制备出高精度线路层。
DBC 工艺原理与材料特性
1. 高温共晶键合机制
反应条件:在 1065~1083℃下,铜箔与陶瓷(Al₂O₃/AlN)表面通过氧元素形成 Cu-O 共晶液
冶金结合:
生成中间相(CuAlO₂或 CuAl₂O₄)
铜层与陶瓷实现原子级键合,界面结合强度 > 40 MPa
DBC 基板核心材料对比
| 材料 | Al₂O₃ | AlN |
|---|---|---|
| 热导率 | 24 W/(m·K) | 170 W/(m·K) |
| 热膨胀系数 | 7.2×10⁻⁶/K | 4.3×10⁻⁶/K |
| 绝缘强度 | 15 kV/mm | 12 kV/mm |
| 成本 | 低 | 高 |
| 典型应用 | 中功率 LED、常规 IGBT 模块 | 激光器、新能源汽车电机控制器、真空电子器件 |
关键特性解析
氧化铝Al₂O₃陶瓷基板
优势:高绝缘性(10¹³ Ω・cm)、化学惰性、机械强度(抗弯强度 350 MPa)
局限:热导率仅为 AlN 的 14%,与 Si(3.5×10⁻⁶/K)热膨胀系数失配率超 100%
氮化铝AlN陶瓷基板
性能突破:
热导率接近铜的 1/10(Cu=401 W/(m・K))
热膨胀系数与 GaN(5.5×10⁻⁶/K)匹配度达 80%
特殊优势:
低二次电子发射系数(δ<1.0),适用于高功率真空器件输能窗口
无毒性(对比 BeO 陶瓷),符合环保要求
DBC 工艺核心特性与工程价值
1. 绝缘性能
| 材料类型 | 绝缘强度 | 绝缘电阻 | 应用优势 |
|---|---|---|---|
| Al₂O₃-DBC | 15 kV/mm | >10¹³ Ω·cm | 高压变频器、电焊机安全隔离 |
| AlN-DBC | 20 kV/mm | >10¹³ Ω·cm | 激光二极管高压驱动防护 |
2. 热导性能
热导率:
Al₂O₃-DBC:24 W/(m・K)(铜层厚度 0.3 mm 时热阻≈0.5 K・cm²/W)
AlN-DBC:170 W/(m・K)(铜层厚度 0.6 mm 时热阻≈0.15 K・cm²/W)
散热效率:比传统 PCB 基板(导热率 <1 W/(m・K))提升 100 倍以上
3. 热膨胀匹配
关键参数:
AlN 热膨胀系数:4.3×10⁻⁶/K(与 Si 的 3.5×10⁻⁶/K 匹配度达 80%)
Al₂O₃热膨胀系数:7.2×10⁻⁶/K(与 Si 失配率超 100%)
工程价值:
减少芯片封装热应力(应力值降低 40%~60%)
支持多芯片直接焊接(减少导热界面层)
4. 载流能力
铜层参数:
厚度范围:0.1~3 mm
载流量:1 mm 铜层可承载 100 A/cm(@温升 50℃)
典型应用:新能源汽车电机控制器(峰值电流 > 2000 A)
5. 图形化能力
精度指标:
最小线宽 / 线距:50 μm(常规工艺)
精细工艺:≤25 μm(适用于高密度封装)
设计自由度:支持复杂电路布局(如 IGBT 模块三相桥结构)
6. 界面结合力
附着力:>40 MPa(ASTM D3359 测试标准)
可靠性验证:
高温高湿测试:85℃/85% RH 环境下无剥离(1000 小时)
冷热冲击测试:-55℃~+250℃循环 10⁶次无失效
1. 电力电子领域
IGBT 模块封装
优势:0.3~3 mm 厚铜层(载流能力 > 100 A/cm)+ AlN 基板(热导率 170 W/(m・K))
应用案例:
新能源汽车电机控制器(800 V 平台 IGBT 模块)
智能电网高压变频器(6.5 kV IGBT 模块)
功率混合电路
需求匹配:
高绝缘性(15~20 kV/mm)保障高压隔离
热膨胀系数与 Si 芯片(3.5×10⁻⁶/K)高度匹配
2. 光电子领域
| 应用场景 | DBC 技术价值 | 典型参数 |
|---|---|---|
| 半导体激光器(LD) | AlN 基板热导率 170 W/(m・K),降低结温至 < 45℃ | 单管功率≥50 W,光束质量因子 M²<1.2 |
| CO₂激光器 | 铜层厚度 0.6 mm,实现均匀散热 | 输出功率 > 10 kW,电光转换效率 20% |






