
用于芯片级封装的DPC陶瓷基板结构图
2025-06-24 11:26:12
165
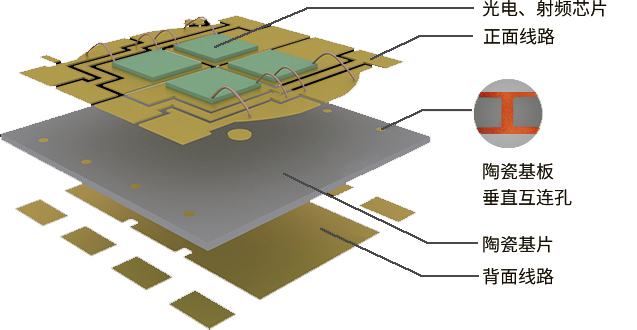
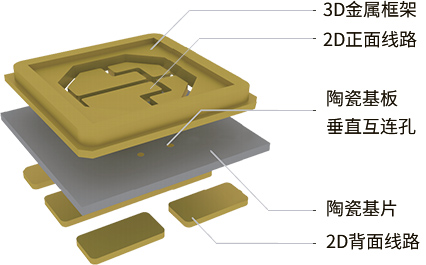
薄膜电路陶瓷封装基板采用磁控溅射薄膜沉积结合电镀增厚技术制造。该工艺首先在高导热陶瓷基体表面进行薄膜金属化,并通过影像转移技术精确形成2D金属线路。随后,利用TCV (Through Ceramic Via) 技术实现双面布线间的垂直互连。最终,通过金属层堆叠工艺,形成与陶瓷基体结合紧密、一体成型的3D金属框架。
基于此薄膜工艺:
金属化层厚度可调: 通过磁控溅射与电镀工艺,铜层与金层的厚度可在 1μm 至 1mm 范围内精确控制。
高精度布线: 可实现 ≤ 0.05mm 的最小线宽/线距。
上一篇:陶瓷基板材料常见热导率






