
首页/新闻动态/高温共烧陶瓷(HTCC):分类、特性与应用全景
高温共烧陶瓷(HTCC):分类、特性与应用全景
什么是高温共烧陶瓷(HTCC)
HTCC是指,按电路设计要求,将钨、钼、钼、锰制成的高熔点金属浆料,通过丝网印刷,将电路印制在92~96%氧化铝陶瓷(含4%~8%的烧结助剂)生瓷片上,生瓷片经层压、切割等工序后,在1500至1600°C的高温下共烧结,从而得到多层陶瓷电路板。
HTCC 产品具有以下显著特点:
卓越的可靠性: 耐腐蚀、耐高温、使用寿命长。
优异的热性能: 导热性好、热补偿迅速、温度分布均匀。
高效节能: 得益于其优良的热管理特性。
环保合规: 不含铅 (Pb)、镉 (Cd)、汞 (Hg)、六价铬 (Cr6+)、多溴联苯 (PBB)、多溴二苯醚 (PBDE) 等有害物质,符合欧盟 RoHS 等严格环保法规要求。

由于氧化铝/氮化铝陶瓷的烧成温度高,HTCC不能采用金、银、铜等低熔点金属材料,而必须使用钨、钼、锰等难熔金属材料。但是钨、钼、锰这些材料具有低电导率并引起信号延迟等缺陷,因此不适合用于高速或高频微组装电路的基板。
但是相对于LTCC基板,HTCC基板具有结构强度高、导热性高、化学稳定性好、布线密度高等优点。
HTCC陶瓷发热板是一种新型的高效环保节能陶瓷发热元件。产品广泛应用于日常生活、工农业技术、军工、科、通讯、医疗、环保、航空航天等诸多领域。
HTCC 的分类(基于陶瓷材料)
高温共烧陶瓷 (HTCC) 主要根据所使用的陶瓷基板材料进行分类,目前主流为 氧化铝 (Al₂O₃) 和 氮化铝 (AlN) 两种体系,两者在性能、工艺和应用上存在显著差异。
氧化铝 (Al₂O₃) HTCC
技术成熟度: 是目前相对成熟且应用广泛的微电子封装技术。
材料组成: 陶瓷基板通常由 92% - 96% 的氧化铝 添加 4% - 8% 的烧结助剂(如玻璃相)组成。
工艺特点:
烧结温度: 1500°C - 1600°C。
导体材料: 钨 (W)、钼 (Mo) 及其合金(如 钼锰合金 (Mo-Mn) )等难熔金属。
核心优势: 工艺成熟、成本相对较低、机械强度高、化学稳定性好、布线密度高。
氮化铝 (AlN) HTCC
核心优势: 氮化铝基板最突出的优点是具有极高的热导率(通常比氧化铝基板高出一个数量级),是解决高功率密度器件散热问题的理想选择。
主要缺点/挑战:
导体电阻率高,信号损耗大: 受限于必须使用钨、钼等高电阻率难熔金属导体,导致信号传输损耗较大,延迟增加。
高烧结温度与能耗: 所需烧结温度更高(通常 >1600°C),导致工艺能耗大,成本增加。
相对较高的介电常数: 其介电常数高于LTCC中常用的低介电常数陶瓷材料,这对高频高速信号传输不利。
共烧后导热系数下降: 与钨、钼导体共烧后,基板整体的导热系数会低于纯氮化铝材料的理论值。
表面金属化要求:
必须镀镍: 暴露在外的钨/钼导体极易氧化,必须进行镀镍处理以形成保护层。
功能增强: 镍层同时起到降低接触电阻、提供可焊性和实现引线键合的关键作用。
HTCC应用于集成封装
概述
多层布线陶瓷基板与金属外壳、金属密封圈框架、金属底板和连接器等一个或多个金属部件焊接在一起,形成具有一定气密性的陶瓷和金属一体化封装结构。这种结构使得基板不仅作为多层电路互连基板,而且作为封装结构的一部分,焊接盖板后,可以实现多层电路的气密封装。
在集成封装应用中,高温共烧陶瓷(HTCC)技术通过将多层布线陶瓷基板与金属封装部件(如外壳、密封圈框架、底板、连接器等)进行焊接,构建出陶瓷-金属一体化气密性封装结构。
此结构的关键在于:
功能集成: HTCC基板不仅承担高密度电路互连的核心功能;
结构角色: 同时作为封装结构的关键组成部分;
核心优势: 最终与金属盖板焊接后,即可实现高可靠性、高气密性的多层电路封装。
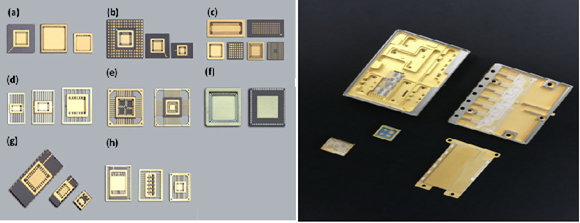
HTCC 产品核心特点
高密度集成: 实现复杂电路的多层互连与高密度组装。
小型化与轻量化: 结构紧凑,显著减小封装体积与重量。
高可靠性: 优异的耐高温、耐腐蚀性能及结构稳定性,确保长期可靠运行。
关键性能与技术指标
封装外壳材质: 铝 (Al)、硅 (Si)、可伐合金 (Kovar)、钛合金 (Ti) 等。
气密性 (氦质谱检漏): ≤ 1 × 10⁻³ Pa · cm³/s (确保内部环境稳定性)。
焊缝空隙率: ≤ 15% (表征焊接质量与密封可靠性)。
绝缘电阻 (500 V DC): ≥ 10¹⁰ Ω (保证优异的电气隔离性能)。
驻波比 (VSWR) (典型值): ≤ 1.3 (适用于射频应用,表征信号反射/匹配性能)。
典型应用产品
微波射频模块: 发射/接收 (TR) 模块、上下变频器、多通道收发组件等。
高密度集成模块: 系统级封装 (SiP) 电路、多功能混合集成模块。
光通信器件: 高速光收发模块核心载体/次模块等。
其他高可靠性微系统: 传感器封装、高功率密度器件封装等。
主要应用领域
微波/射频通信: 雷达、卫星通信、基站等。
电子战 (EW) / 电子对抗 (ECM): 高性能射频前端。
光通信: 高速数据中心互联、骨干网传输设备。
功率电子: 大功率半导体器件 (如 IGBT, SiC/GaN) 封装基板。
航空航天与国防: 航空电子、制导系统、星载设备。
高性能计算: 特定高可靠性计算模块。
医疗与工业设备: 高端传感器、精密仪器核心封装。