
微机电系统MEMS陶瓷封装技术与应用
与传统单一功能器件不同,微机电系统(MEMS)是一种集微机械结构、传感器、执行器及电子元器件于一体的微型化系统。该类器件具备体积小、重量轻、成本低、功耗低、可靠性高、适于批量生产及易于集成化等优势,因而对其封装提出了更高要求:封装不仅需保护内部电路与结构免受外界环境干扰,还需为微纳尺度的机械部件提供稳定、可控的物理环境。
不同MEMS产品在功能与结构上的多样性,也决定了其制造工艺与封装形式的特异性。在各类封装方案中,陶瓷封装凭借其优异的气密性、良好的热机械性能、高绝缘性以及出色的高温稳定性,在要求高可靠性与长寿命的应用中,通常展现出比金属或塑料封装更佳的综合性能。
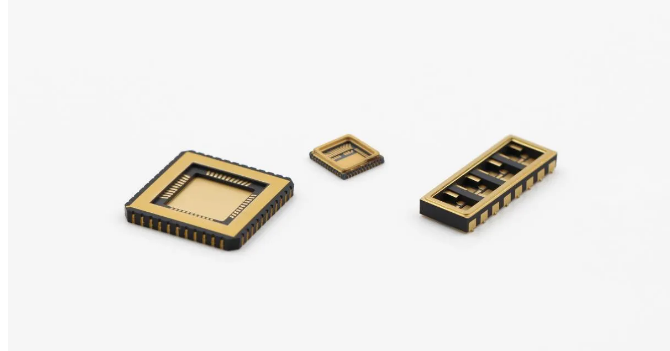
常用陶瓷封装材料及其特性
氧化铝(Al₂O₃)
作为目前技术最成熟、应用最广泛的陶瓷封装材料,氧化铝在综合性能与成本之间实现了良好平衡。其具备极高的电阻率(约10¹⁴ Ω·cm)与高介电强度,绝缘性能优异,广泛用于各类传感器基板与封装外壳。然而,其热导率相对较低,因此在高功率密度场景中的应用受到限制。
氮化铝(AlN)
氮化铝以高导热性为主要特点,导热系数可达170–200 W/m·K,远高于氧化铝。同时,其热膨胀系数与硅芯片接近,能够显著降低热应力,提升器件在温度循环条件下的可靠性。因此,氮化铝常用于大功率LED、激光雷达、高性能处理器及战术级MEMS传感器等需要高效散热的场合。
氮化硅(Si₃N₄)
氮化硅以高机械强度和优异耐化学腐蚀性著称,其断裂韧性与弯曲强度极为突出,能够为MEMS敏感结构提供出色的抗冲击与抗振动保护。受限于较高的制造成本,它主要应用于机械可靠性与环境耐受性要求极高的特殊领域,而非普通消费电子。
陶瓷封装形式与关键工艺
共烧陶瓷(LTCC/HTCC)
该工艺通过将多层陶瓷生坯与金属布线在高温下一次共烧,形成具备复杂三维互连结构的气密封装体。其优势在于适于规模化制造,有助于降低成本,并可实现高密度布线与集成无源元件(如电阻、电容、电感),从而显著提升MEMS器件的集成度与微型化水平。
气密封装
该结构是保障高灵敏度MEMS器件(如陀螺仪、谐振器)长期稳定运行的关键。工艺上通常在陶瓷基表面制作金属化密封环,再通过玻璃钎焊或激光焊接与盖板实现密封,形成内部惰性或真空环境,有效隔绝外界水汽与污染物,确保微结构在寿命周期内性能不退化。
微通道陶瓷封装
该封装形式面向微流体控制与传感类MEMS器件,利用激光烧蚀、精密注模或溶液涂层堆叠等工艺,在陶瓷基板内部直接加工出微流体通道。此类结构是实现微流体控制器、生物芯片及气体传感器等功能器件的关键,能够精确调控流体与传感单元之间的相互作用,适用于生化检测、环境监测等应用场景。
热门新闻

方寸铸硬核,精工造非凡|百能云板12层3阶HDI板,助力工业智能进阶

AI高功耗倒逼材料迭代:陶瓷基板开启PCB替代与国产替代新周期




