一、什么是玻璃基板芯片技术—TGV
TGV(Through Glass Via)技术,即玻璃通孔技术,是一种穿过玻璃基板的垂直电气互连技术。它可以在玻璃基板上形成垂直的电气连接,实现芯片与芯片、芯片与基板之间的高密度互连。在硅转接板上穿越中介层的是TSV技术(硅通孔),而在玻璃转接板上穿越的中介层就是TGV(玻璃通孔)。
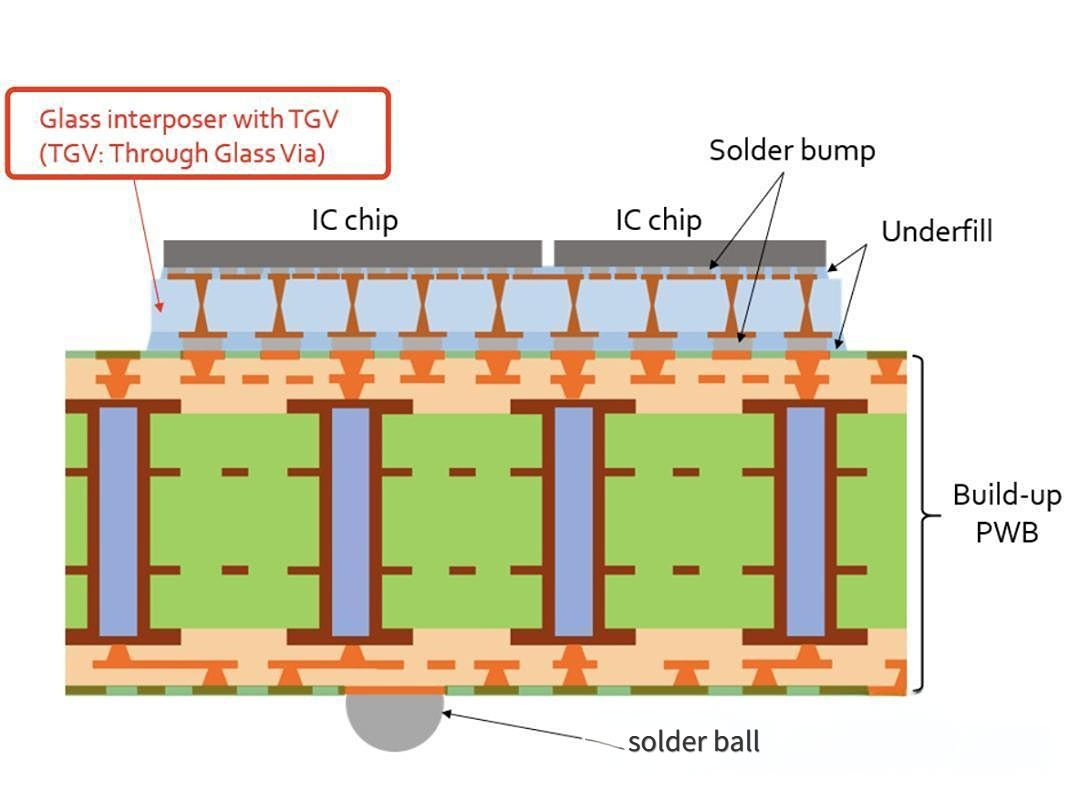
玻璃通孔(Through-Glass Via, TGV)互连技术最早可追溯至2008年, 衍生于2.5D/3D集成TSV转接板技术, 主要用来解决TSV转接板由于硅衬底损耗带来高频或高速信号传输特性退化、材料成本高与工艺复杂等问题。近年来技术日趋完善。各家头部公司开始布局,并生产出一些样品应用于不同的领域包括:传感器,CPU,GPU,AI,显示面板,医疗器械,半导体先进封装等。
玻璃通孔(TGV)和硅通孔(TSV)工艺相比TGV的优势主要体现在:1)优良的高频电学特性。玻璃材料是一种绝缘体材料,介电常数只有硅材料的1/3左右,损耗因子比硅材料低2-3个数量级,使得衬底损耗和寄生效应大大减小,保证了传输信号的完整性;2)大尺寸超薄玻璃衬底易于获取。Corning、Asahi以及SCHOTT等玻璃厂商可以提供超大尺寸(>2m × 2m)和超薄(<50µm)的面板玻璃以及超薄柔性玻璃材料。3)低成本。受益于大尺寸超薄面板玻璃易于获取,以及不需要沉积绝缘层,玻璃转接板的制作成本大约只有硅基转接板的1/8;4)工艺流程简单。不需要在衬底表面及TGV内壁沉积绝缘层,且超薄转接板中不需要减薄;5)机械稳定性强。即便当转接板厚度小于100µm时,翘曲依然较小;6)应用领域广泛,是一种应用于晶圆级封装领域的新兴纵向互连技术,为实现芯片-芯片之间距离最短、间距最小的互联提供了一种新型技术途径,具有优良的电学、热学、力学性能,在射频芯片、高端MEMS传感器、高密度系统集成等领域具有独特优势,是下一代5G、6G高频芯片3D封装的首选之一。图1,(a) 准备玻璃晶圆,(b)形成TGV,(c)PVD阻挡层,种子层,双面电镀-沉积铜,(d)退火及CMP化学机械抛光,去表面铜层,(e)PVD镀膜及光刻,(f)布置RDL重布线层,(g)去胶及Cu/Ti 刻蚀,(h)形成钝化层(介电层)。首先,来料检测,制作玻璃通孔(TGV)。TGV 的成孔工艺主要包括喷砂、超声波钻孔、湿法刻蚀、深反应离子刻蚀、光敏刻蚀、激光刻蚀、激光诱导深度刻蚀以及聚焦放电成孔等。孔形成后,需要检测,清洗;图2普通激光钻孔工艺与激光诱导深度刻蚀工艺对比(图片来源:LPKF)孔形成后,要对孔进行检测,如通孔率,异物,面板缺陷等1:通孔率 - 漏点以及不通。孔径大小:规格-10/30/50/70/100,外径需要比内径的比例大于60%以上。缺陷判断标准:面积;真圆度(95%卡控);直径(±5um)。 2:孔内异物:有无,看通断,玻璃渣,碳纤维,胶类,粉尘。3:面板缺陷:裂纹,ETCH不良(凹坑),赃物,划痕。其次,通过物理气相沉积(PVD)的方法在玻璃通孔内部沉积阻挡层,种子层;最后,通过临时键合,背面研磨、化学机械抛光(CMP)露铜,解键合,形成玻璃通孔(TGV)工艺技术金属填实转接板。过程中,也需要清洗,检测等半导体工艺。(a) LIDE drilling - 激光诱导蚀刻钻孔(b) Electroplating filling - 电镀填充(d) Front side RDL formation - 正面再分布层(RDL)形成(e) Polyimide layer - 聚酰亚胺层(g) Temporary bonding - 临时键合(h) Backside grinding & RDL formation - 背面研磨和再分布层(RDL)形成(i) Carrier wafer de-bonded - 载体晶片去键合下表为主要的工艺流程以及对应的设备,各个厂商在具体工艺路线上,或者细节上有不同;比如对于要求低,尺寸大的成孔,可以采用机械钻孔。在金属化工艺中,也有采用塞孔铜浆料替代电镀;也有报道,无需PVD电镀,而直接采用湿法进行镀铜;还有,同时激光诱导改性及湿法蚀刻制作TGV连通孔和RDL重布线层,再通过溅射种子层及在种子层上沉积导电材料以 形成TGV和RDL,减少了传统工艺中需要进行两次掩膜、显影及蚀刻,有效的简化了工艺流程,提高了工作效率。总之各家工艺路线大同小异,根据实际的应用进行调整。