
用于芯片级封装的DPC陶瓷基板结构示意图
2025-09-02 10:15:11
200
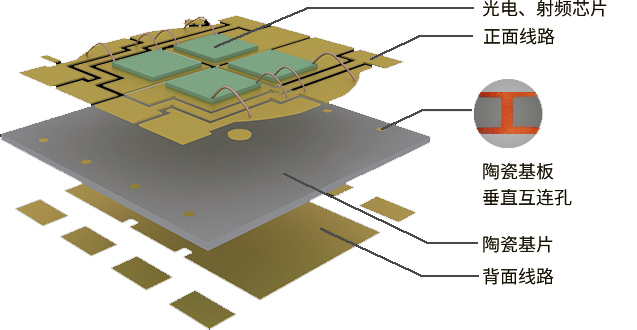
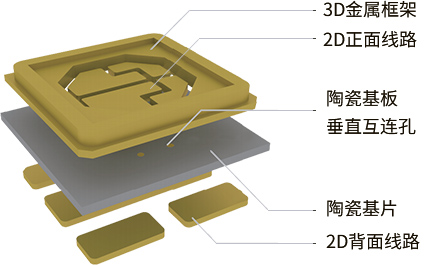
本产品采用先进的薄膜电路工艺(磁控溅射与电镀相结合),在高导热陶瓷基板上构建高精度二维线路与TCV垂直互连,并通过堆叠技术形成一体化3D金属框架。其铜/金层厚度可在1μm至1mm间灵活定制,并实现0.05mm的极小线距,为芯片级封装提供卓越的互连解决方案。
基于薄膜工艺的一体化3D陶瓷封装基板
核心技术:
精密金属化: 采用磁控溅射与图形电镀技术,实现陶瓷表面的高结合力金属化。
高密度互连: 融合微细2D线路(线距≥0.05mm)与TCV陶瓷通孔技术,实现芯片的双面垂直互连。
坚固一体化结构: 通过堆叠技术形成与陶瓷基体结合紧密的3D金属框架,结构可靠。
卓越性能:
定制化镀层: 铜、金层厚度可在1μm至1mm范围内任意定制,满足多样电气与热管理需求。
优异导热基础: 依托高导热陶瓷基体,确保芯片高效散热。
高可靠性: 为芯片提供气密性保护和高性能的互联平台。
上一篇:陶瓷基材不导电,为何能导热?
下一篇:软硬结合板设计实例解析






