
低温共烧陶瓷(LTCC)封装核心材料全解析
低温共烧陶瓷(Low Temperature Co-fired Ceramics,LTCC)封装是一种将不同种类芯片等元器件集成于同一封装内以实现系统功能的技术,是实现系统小型化、集成化、多功能化和高可靠性的重要手段。
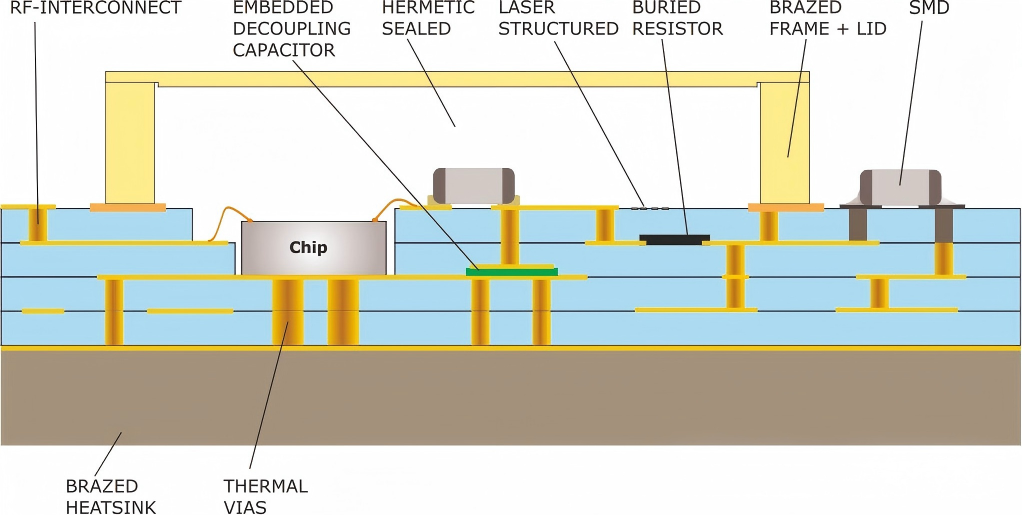
LTCC封装材料指用于承载元器件及其互连、并提供机械支撑、环境保护、信号传递、散热和屏蔽等功能的基体材料,主要包括LTCC基板材料、封装金属材料和焊接材料三大类。
LTCC基板材料

LTCC基板材料主要包括生瓷带及其配套的导体、电阻等材料。
① 导电浆料
LTCC中用于布线和通孔连接的导体材料常以Au、Ag、Pd、Pt等贵金属或其合金(如PdAg、PtAg、PtAu、PtPdAu等)作为导电相,性能稳定、工艺成熟,可在空气气氛中烧结。Cu也具有高电导率、高导热性和良好的焊接性能,适合低温烧结,但由于在空气中易氧化,烧结时需在氮气等中性气氛保护下进行。
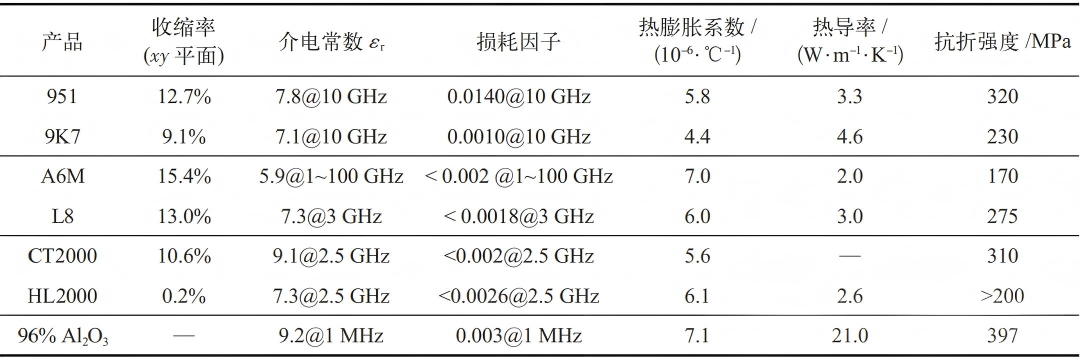
② LTCC生瓷
LTCC生瓷带主要有两类:
玻璃陶瓷系(微晶玻璃):烧结时析出低介电常数、低损耗的微晶相,适用于高频组件或模块基板。
玻璃+陶瓷系:以玻璃为烧结助剂,陶瓷为主晶相,可改善力学与热性能,介电常数和损耗一般高于微晶玻璃,多用于中低频电路基板。
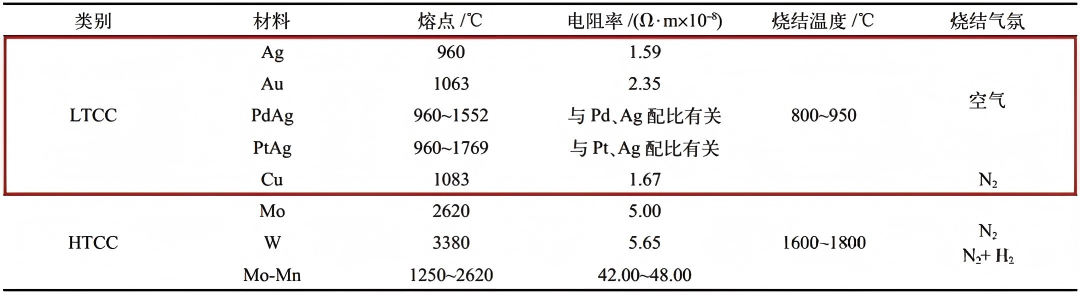
对传输线路而言,低介电常数有利于信号高速传输(信号延迟时间正比于介电常数的方根);而高介电常数可缩小微波器件尺寸。
LTCC封装金属材料
选择时需综合考虑热导率、热膨胀系数、密度、可焊性及工艺成熟度等因素。

① 可伐合金
成分为Fe-Ni-Co(镍29%、钴18%),热膨胀系数与常用LTCC基片匹配,加工性好、成本低,是常用金属管壳材料,但其热导率较低,限制了在某些高热应用中的使用。
② CuW/CuMo合金
兼具W/Mo与Cu的优良特性,具有高导热导电性、耐电弧侵蚀、抗熔焊、耐高温抗氧化等优点,热膨胀系数可调,常用于大规模集成电路和大功率微波器件作为热沉或引线框架。但其密度较大,在轻量化要求高的便携设备及航空航天领域应用逐渐减少。
③ 铝硅合金
具有质量轻、热膨胀系数低、导热性好、强度高、易加工、成本低等优点,且可与金、银、镍镀层结合,是一种备受关注的电子封装材料。
④ AlSiC
具有高热导率、低膨胀系数、高强度、低密度和良好导电性,已在国内外作为基板或热沉材料批量应用。
LTCC封装焊接材料
主要用于LTCC基板与金属底板、围框、引脚之间的连接,以及元器件组装、焊球连接与垂直互连等,属于熔点低于450℃的软钎料。LTCC封装常需多步焊接,为避免后道工序影响前道焊点,不同工序的焊料熔点应形成一定温度梯度。
按成分可分为:
有铅焊料:以铅锡焊料为主,如Sn63Pb37,工艺成熟,焊点可靠性及机械性能较好。
无铅焊料:主要包括金系焊料(如AuSn、AuGe)和锡银系焊料(如SnAgCu)。无铅焊料在某些方面表现优异,如SnAgCu焊料抗张强度更高、抗热疲劳性能好,金锡焊料抗拉强度高、抗氧化性强,代表电子材料无铅化发展方向。
焊料形式主要有焊膏和焊片:焊膏适用于微小元器件、焊球等多点焊接;焊片适用于围框、基板等大面积或尺寸精度要求高的焊接。Au80Sn20、Au88Ge12等焊料需在氮气或真空气氛中焊接,成本较高,主要用于气密性焊接;铅锡、锡银系焊料可在空气中焊接,常用于元器件焊接和垂直互连。






