
先进封装基板技术要点解析
近年来,为适配高性能计算机、新一代移动通信、人工智能、汽车电子及国防装备等关键领域的应用需求,电子产品正加速向高性能、高集成度方向迭代。在摩尔定律逼近物理极限、先进晶圆制程成本持续攀升的行业背景下,先进封装技术在半导体产业链中的战略重要性愈发凸显。作为先进封测产业的核心基础,先进基板是支撑先进工艺下巨量I/O接口提升、实现系统级封装(SIP)的核心载体,更是异质集成技术的关键支撑,在后摩尔时代对国家重点行业与核心领域起到不可替代的保障作用。
二、FCBGA基板
FCBGA(倒装芯片球栅格阵列)有机基板,是专为倒装芯片封装场景设计的高密度集成电路封装基板,其技术核心源于积层法基板技术。该技术最早由IBM公司引入,初期应用于笔记本电脑板级封装,核心目标是在有限空间内实现电子元器件的高密度承载与互联。凭借优异的电气性能与更具竞争力的制造成本优势,积层法基板逐步替代陶瓷基板,在倒装芯片封装领域获得广泛应用。后续在英特尔公司的持续推动下,该技术不断成熟并实现标准化,最终全面应用于其全系列CPU产品。
近年来,伴随人工智能、5G通信、大数据等技术的飞速发展,市场对高性能CPU、GPU、FPGA及网络路由器/转换器专用芯片的需求呈爆发式增长,直接导致大尺寸FCBGA封装基板市场出现严重产能缺口。FCBGA基板因具备层数多、面积大、布线密度高、线宽线距精细、微孔(通孔、盲孔)孔径微小等技术特征,其加工制造难度显著高于FCCSP等其他类型封装基板。
从全球产业格局来看,FCBGA封装基板的产能与技术主要集中在中国台湾、日本、韩国等地区,代表性企业包括三星电机、南亚电路板、欣兴电子、京瓷、景硕科技等。中国大陆目前仅有深南电路、越亚半导体、华进半导体等少数企业具备小批量量产能力,产品技术指标已可实现线宽/线距15/15 μm、盲孔直径≤40 μm。总体而言,中国大陆在FCBGA基板领域的技术突破与产能扩张仍有巨大发展空间。图1展示了小批量量产的FCBGA封装基板样品。
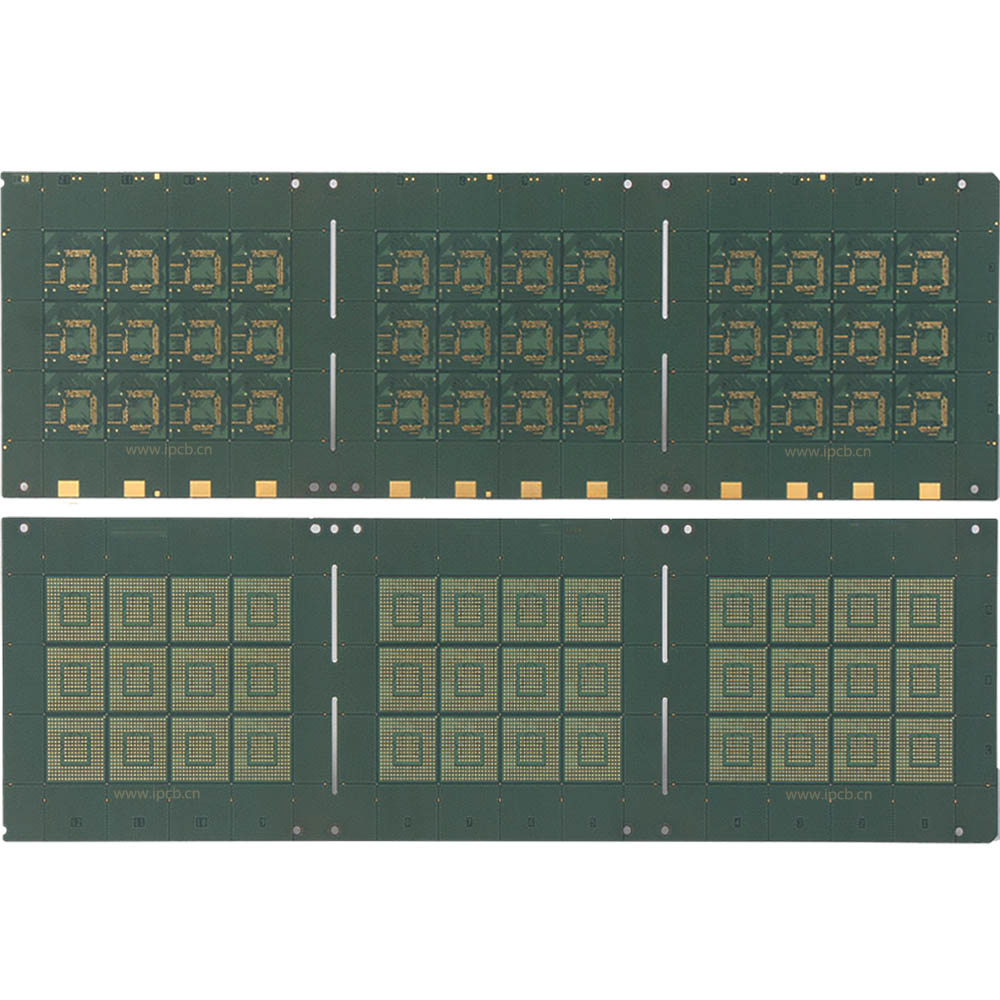
国产FPGA产品
FCBGA封装基板的制造通常采用日本味之素公司生产的ABF(味之素积层介质薄膜)作为积层绝缘介质材料,搭配半加成法工艺实现加工。ABF材料是一种兼具低热膨胀系数、低介电损耗特性的热固性薄膜,因其易于加工精细线路、机械性能优良且耐久性强,已成为FCBGA封装基板的标准积层介质材料。当前,高密度大尺寸FCBGA封装基板的研发重点主要聚焦于ABF材料工艺优化、薄型FCBGA封装基板技术突破及细线路加工工艺升级三大方向。
已有学者针对味之素公司推出的高频场景专用低介电常数、低介电损耗ABF材料GL102,系统开展了压合、预固化、除胶、激光打孔等关键工艺参数对ABF与铜层结合力及盲孔加工质量的影响规律研究。该研究旨在解决GL102材料在实际应用中可能出现的ABF-Cu结合力不足、胶渣难以彻底清除等工艺痛点,进而降低由此引发的封装可靠性风险。
三、无芯封装基板
根据是否包含芯板(核心支撑层),IC封装基板可分为有芯基板与无芯基板两大类。
有芯基板主要由中间芯板及上下两侧积层板组成,无芯基板则是去除芯板结构的封装基板,仅由积层板堆叠形成。图2为有芯基板与无芯基板的结构示意图,图3为某类无芯封装基板的制造流程示意图——该方法以双面铜箔聚酰亚胺(PI)为基材,以PI膜作为绝缘层,通过加成法实现高密度布线。
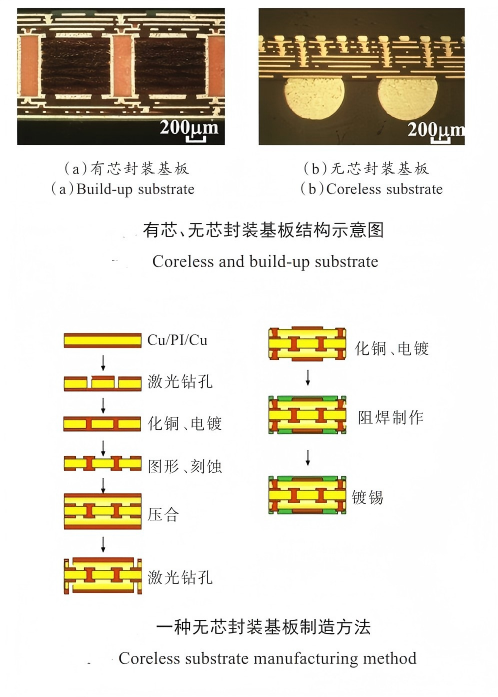
消费类电子产品持续向轻薄化、小型化方向发展,这一趋势直接驱动封装基板向更轻、更薄、更高集成度的方向演进。2004年,富士通公司率先推出全球首款无芯封装基板“GigaModule-4”。此后,在基板制造商与终端电子产品品牌企业的协同推动下,无芯封装基板技术逐步成熟,目前已在智能手机、平板电脑等消费类电子产品中实现规模化应用。国内厂商如越亚半导体、深南电路、兴森快捷等已具备与国际先进水平比肩的无芯封装基板技术实力。
传统有芯基板因包含较厚的刚性芯板层,且芯板通孔直径与其他层差异较大,在高频信号传输过程中易产生信号反射、延迟等问题,影响信号完整性。相比之下,无芯基板的厚度仅为传统有芯基板的三分之一,不仅更契合消费电子产品“轻薄短小”的发展需求,还具备显著优势:信号传输速率更快、信号完整性更优、阻抗更低、布线设计自由度更高,且可实现更精细的图形与线距。
但受限于缺少刚性芯板的机械支撑,无芯封装基板存在结构强度不足、易发生翘曲变形等短板。因此,如何有效控制无芯封装基板在制造及组装全过程中的翘曲变形,已成为其研发与量产阶段的核心技术课题。
以下是FCBGA和无芯封装基板的对比
对比维度 | FCBGA基板 | 无芯封装基板 |
|---|---|---|
基板类型 | 有机基板,倒装芯片球栅格阵列封装专用 | 无芯结构,仅由积层板组成(去除芯板) |
核心技术来源/工艺 | 源于积层法基板技术,采用半加成法工艺 | 基于积层技术,采用加成法工艺(以PI为基材) |
关键技术指标 | 线宽/线距15/15 μm,盲孔直径≤40 μm(国内小批量水平); 层数多、面积大、布线密度高 | 厚度为传统有芯基板1/3; 可实现精细图形与线距,布线设计自由度高 |
核心材料 | 主要采用ABF(味之素积层介质薄膜),如高频专用GL102材料 | 以双面铜箔聚酰亚胺(PI)为基材,PI膜作为绝缘层 |
电气性能 | 电气性能优异,适配高频场景(低介电常数、低介电损耗) | 信号传输速度更快、信号完整性更优、阻抗更低 |
结构特性 | 结构刚性较强(依赖积层与布线结构),加工难度高 | 结构轻薄,但无芯板支撑,易翘曲、结构强度不足 |
应用领域 | 高性能CPU、GPU、FPGA、网络路由器/转换器专用芯片等 | 智能手机、平板电脑等消费类电子产品(轻薄化需求场景) |
国内外代表企业 | 全球:三星电机、南亚电路板、欣兴电子、京瓷、景硕科技; 国内:深南电路、越亚半导体、华进半导体、百能云板; | 全球:富士通;国内:越亚半导体、深南电路 兴森快捷(与国际水平比肩) |
核心技术痛点/研发重点 | ABF材料工艺优化、薄型化技术突破、细线路加工; GL102材料ABF-Cu结合力、胶渣清除问题 | 制造及组装过程中的翘曲变形控制 |