
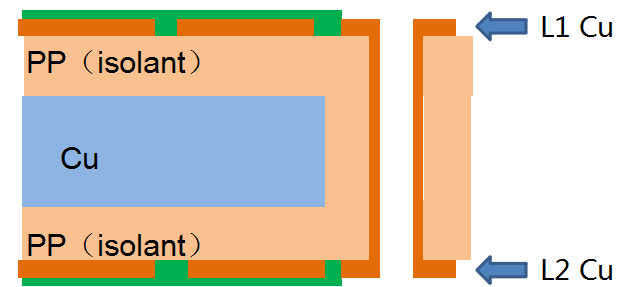
PCB干货:深入铝基板结构,PCB散热设计的关键
铝基板具备可靠的电气绝缘性能和良好的机械加工性能。这种集高效散热、电气安全与易加工于一体的特性,使其成为解决高功率、高密度电子设备散热难题的理想选择,广受市场青睐。
2025-07-29 10:34
2015

柔性FPC板堆叠层结构设计
柔性PCB(Flexible Printed Circuit,FPC)的叠层结构是指由不同功能材料层压组合而成的多层堆叠设计,以满足柔性电路在电气性能、机械强度和可弯曲性等方面的需求
2025-07-18 11:05
3662

氮化铝多层共烧陶瓷基板的化学镀镍钯金工艺
氮化铝多层高温共烧陶瓷(HTCC)基板以其卓越的散热性能(热导率较LTCC基板高约两个数量级)、与芯片匹配的热膨胀系数及低介电损耗,成为高功率应用的理想选择。
2025-07-14 10:00
1727

DPC陶瓷基板电镀铜加厚工艺
在陶瓷基板金属化领域,直接镀铜(DPC)技术因其卓越的高线路精度(线宽/线距≤50μm)、优异的导热性(如氮化铝基板热导率≥170W/mK)及低温制程特性(<300℃),已成为大功率半导体封装的首选方案
2025-07-08 10:30
2013